从光学光刻的原理可知,减小光源波长可以提高分辨率。所以光学光刻经历了从436nm到365nm、248nm,再到193nm的过程,那么极紫外光刻系统为什么会选择13.5nm?极紫外光刻系统为什么会选用全反射式的,而不是之前几代的折射透镜方式?
EUV极紫外光刻的原理是什么?有哪些难点?又是如何解决的?
本文主要内容:
EUV光刻的选择
EUV光源
曝光系统
3.1 真空带来的限制
3.2 多层膜
3.3照明
3.4 投影
3.5更高NA--下一代EUV
3.6工作台
1. EUV光刻的选择--简述
(1) EUV光刻为什么是全反射式的?
所有材料对波长小于40nm的光吸收都很强。对于折射透镜中透镜元件的典型厚度的固体,EUV光的透射率实际上为0。这就排除了EUV光刻曝光系统采用折射式或折反式光学设计的可能性。
(2)EUV光源为什么是13.5nm?
EUV的反射镜依赖的是多层膜技术,多层膜考虑了多种因素最终选择了Mo/Si多层膜,选定了多层膜后,光源需要针对根据多层膜的反射特性优选出的波长进行设计。

2. EUV光源
自然界中,日冕会产生EUV。人工EUV可由等离子源和同步辐射源得到。EUV是最易被空气吸收的谱段,因此其传输环境需高度真空。
(1)产生原理:
13.5nm的极紫外光相当于大约92eV的光子,超越了所有固态物质价电子的电离能。产生EUV,需要物质被激发到等离子态,只有被带多个正电荷的离子束缚的电子才能够发射EUV(由较为深层的电子退激辐射形成)。例如,把+3碳离子继续剥除一个电子的过程需要65eV,其中的电子比普通价电子更受束缚。而带多电荷的正离子存在于热等离子体。
目前用于芯片制造的极紫外光源为:激光等离子体光源(laser-produced plasma,LPP),在LPP中,离子由高强度相干激光脉冲的强电场产生:快速振荡的电场导致电子和离子反复碰撞,产生高价正离子,电子与这些高价离子结合时便会产生高能量的光子。
(2)具体实现:

激光轰击锡滴产生EUV的过程素材源自:ASML官网
ASML的极紫外光刻机的光源中,极紫外光是由液态锡滴产生的等离子体放射产生的(在 ASML 开发的等离子体源中,每秒有 50000 个锡滴被喷射到真空室中),激光器为高功率CO2激光,波长为10.6μm。
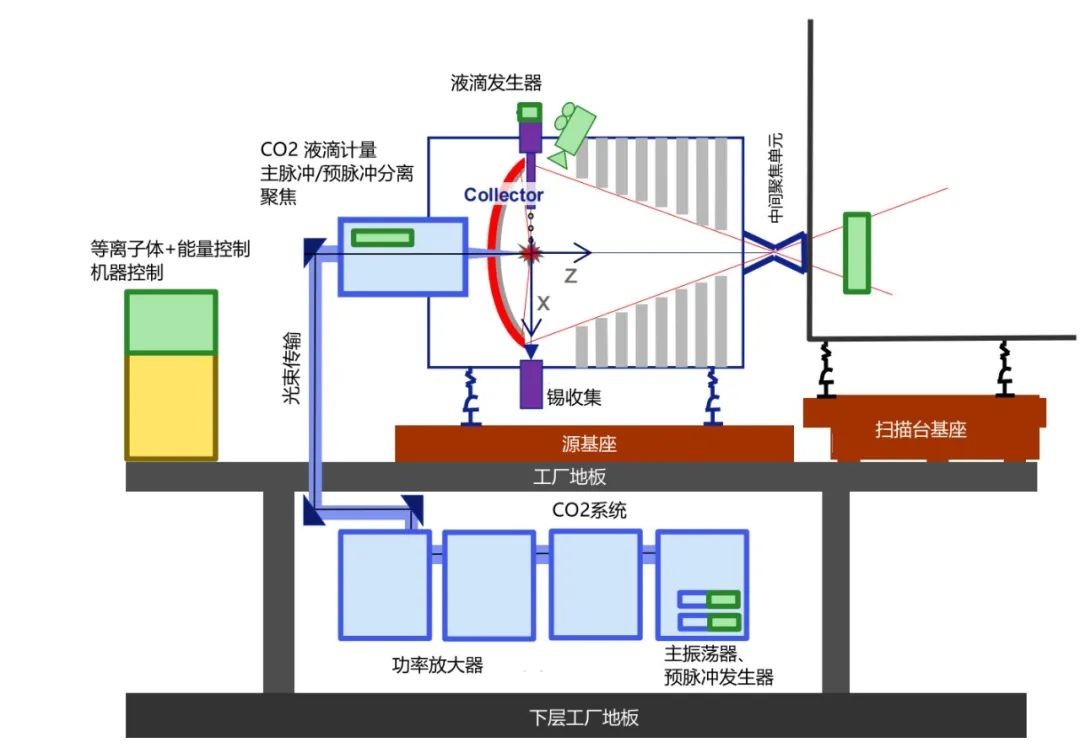
素材源自:ASML官网
如上图所示,激光采用了主振荡器加功率放大器的架构。锡滴的喷射间隔为10~20μs。锡材料的好处是它在13.5nm波段附近有相对较强的EUV辐射谱线,并且锡的熔点很低,只有232℃。

LPP整体素材源自:ASML官网
LPP光源最重要的特性之一是红外光和EUV之间的转换效率。提高效率的一项重要创新是引入了预脉冲:锡滴液首先被一个红外光预脉冲击中,预脉冲的能量比产生等离子体发射出极紫外光的主脉冲能量低很多,但该能量足以将锡液滴变成碟状或部分电离的雾状。当这个碟状靶被随后的主脉冲击中时,能实现接近6%的转换效率。这样的设计,为光源性能带来了很大的提升。
3.曝光系统
3.1 真空带来的限制
由于EUV光会被空气强烈吸收,因此曝光过程中晶圆、透镜、掩膜都必须处于真空中。真空带来了一些限制:
(1) 物镜、晶圆、掩膜的热效应:物镜加热会导致像差,尤其是会导致离焦和套刻误差,晶圆和掩膜的加热也会影响套刻精度。在光学光刻曝光系统中,气流是一种控制物镜和晶圆热效应的有效方法。但EUV的真空要求限制了这种方法:在EUV光刻系统中,气流的压力必须远小于大气压力。低压下的热传输功效十分有限,除非通过使用差分泵实现高气压的空间和EUV光路的分离。
(2)长期以来,高纯气体被用来清扫光学光刻机物镜系统,使镜片免受污染。干式曝光中,气流用来防止底部透镜被光刻胶的释气污染。在EUV中,通常使用低分压氢气。
(3)在光学光刻中,晶圆和掩膜是通过真空方法被夹在各自的卡盘上,卡盘上的吸力来自气压。在EUV光刻系统中,使用的是静电吸盘。
3.2多层膜
所有材料对波长小于40nm的光吸收都很强。阻碍实现波长短于193nm光学光刻的问题,主要是缺乏合适的投射或反射光学材料用于镜片、掩膜及其保护膜的制备以满足微缩投影光刻的要求。在20世纪80年代,多层膜技术得到了开发,可以提供波长在4~25nm波段实用的反射率。正是这一进步,全反射式光学系统的构想得以在光刻技术中实现。
多层膜反射镜通过交替沉积高原子序数和低原子序数材料制备,这种方式将在每一界面提供一个较小的但是有效的折射率差异。通过相长干涉,各个层反射精确叠加时,光会被放大。过程如下:

素材源自:蔡司官网
蔡司将极薄的硅层和钼层气相沉积到玻璃表面上,层厚度只有几纳米,最多有 100 层。最终实现了反射率高达近 70% 。
3.3 照明
与光学光刻机一样,EUV的照明系统具有双重作用:
(1)让光能够均匀地照射在照明狭缝上。
(2)为实现增强分辨率和为光源掩膜优化提供所需调整照明形态的能力。
从中间焦点出来的点光源经过两组可转动反射镜阵列,变成相当均匀的光。可用于照明编程的微镜数量可达数千个,所以照明形态可以实现非常精细的微调:
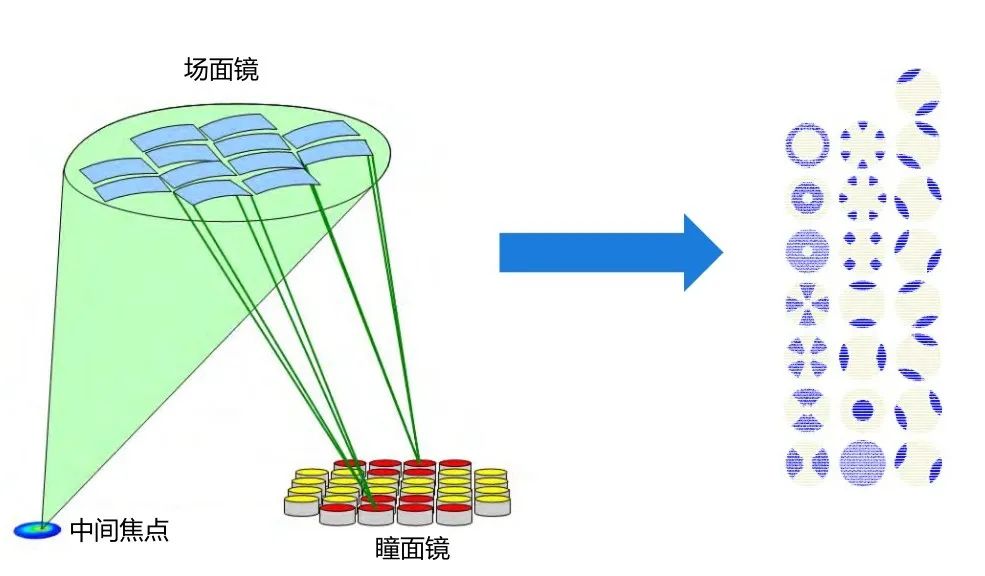
图源:EUV Lithography Industrialization and future outlook .Miyazaki
0.33NA EUV光刻机的照明和投影光学系统结构如下图。照明系统的光束照射反射式掩膜,从掩膜所得到的的光学图案再被若干反射镜组成的物镜投影成像,最后聚焦到晶圆上。
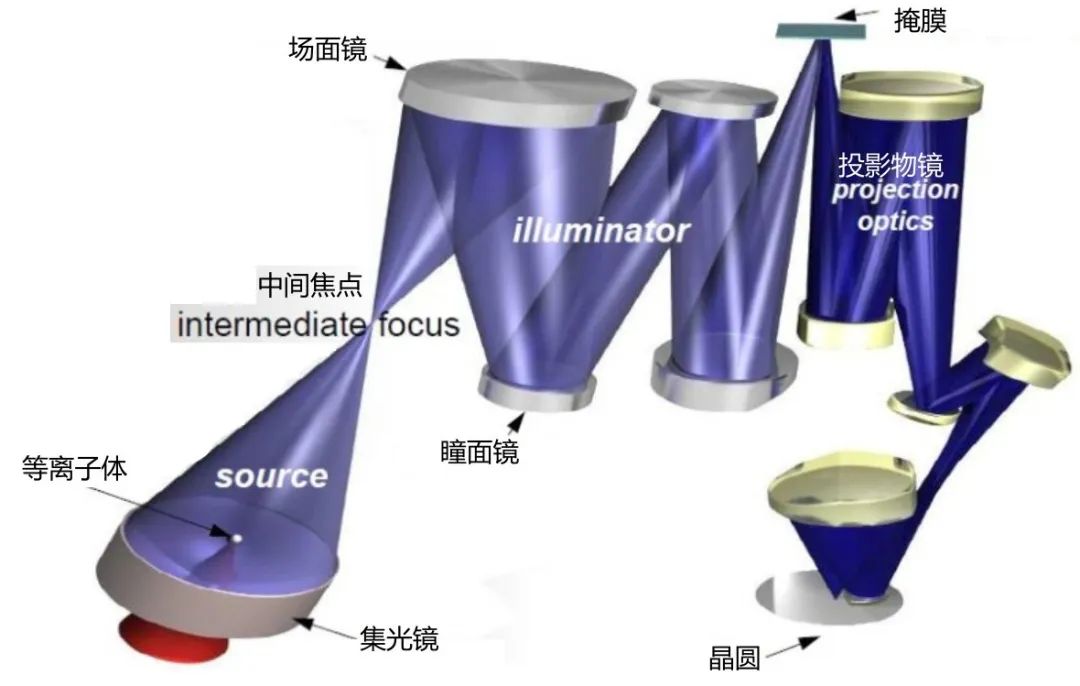
由于EUV系统是反射式的,所以入射到掩膜上的光只能是非法线入射。反射镜表面的反射率与入射角相关,比如:

计算的Mo/Si多层膜反射率
对于0.33NA系统,掩膜的平均入射角为6°,缩小倍率为1 : 4。
3.4 投影
掩膜到晶圆之间为投影部分。目前ASML的EUV投影部分采用了6组物镜,如下图:

图源
投影系统遇到的难点和解决方案:
(1)杂散光:物镜的形貌误差导致了像差;中频粗糙度产生散射,并降低了成像质量;高频粗糙度造成了光强度的损失。解决方法有:避免出现和抛光工具尺寸统一尺度的镜面粗糙度、改善底层基板粗糙度、通过光学邻近进行修正等。
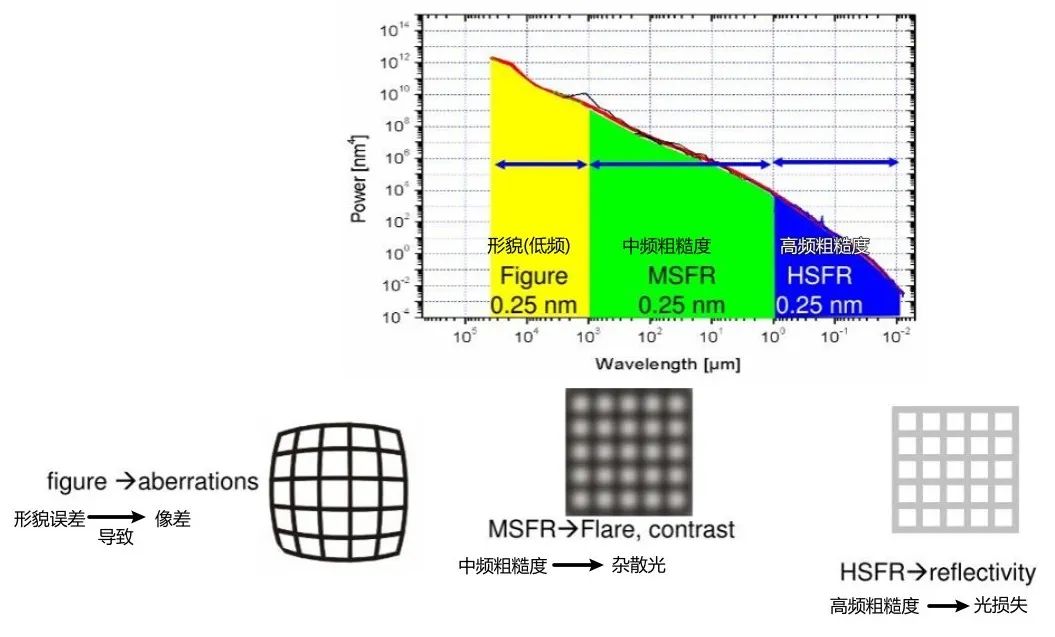
素材源自:P. Kurs. The EUV alpha demo tool program at Carl Zeiss SMT AG. 2004
3.5 更高NA(数值孔径)--下一代EUV
根据瑞利判据公式可知,想要提升分辨率,可以通过增大数值孔径NA来实现。在现有的光学系统中,增加NA的问题:增加NA相当于加宽了掩模反射的光束的角度和投射到晶圆上的光束的角度。投影光学系统由六个反射镜组成。它们通常通过从最靠近掩模的一侧开始的 1 (M1) 到 6 (M6) 之间的数字来区分,物镜为M6。
将NA从0.25提高到0.33时没有问题,但将NA从0.33提高到0.55时,物镜(M6)前面的反射镜(M5)出现问题:M5镜片要让光线以更高的角度进入M6镜片,还必须以更宽的发散角将光线引导到M6镜片。标准 EUV 涂层无法实现反射M5上的大角度和发散角。
因此, 蔡司设计了一种光学系统:通过在M5和M6镜片的中心打孔来让EUV光通过。
素材源自:High NA EUV optics - preparing lithography for the next big step。Paul Gräupner,Peter Kürz,Judon Stoeldraijer ,Jan van Schoot 。
M4镜头反射的光线穿过M6镜头中心的孔,到达M5镜头。M5透镜反射的光束被M6透镜(物镜)反射。反射光穿过M5透镜中心的孔到达晶圆。这样就减小了 M5 镜头处的光束角度,从而实现了对比度和分辨率。
另外,通过将光学系统的反射透镜的数量从传统的六个增加到八个,则无需在反射透镜上钻孔即可实现0.55的NA。然而,添加两个反射透镜,EUV光的能量减少了一半以上。因此,为了保持吞吐量,光源输出必须加倍。因此,ASML的NA为0.55的光刻系统并没有采用八透镜光学系统。
当 NA 想达到更高的0.7 时,实现的方法就变得有限:添加两个反射透镜,并且同时在一些反射透镜上钻孔。
3.6工作台
光学光刻中,晶圆和掩膜平台采用的是空气轴承。在EUV中,采用的是磁轴承。
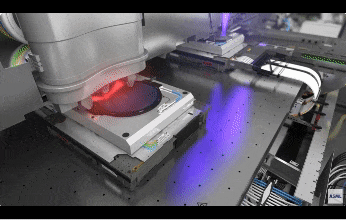
EUV的工作台 素材源自:ASML官网
在工作台的底部有一个磁体阵列。工作台运动是通过在台下方的定子绕组的驱动电流来实现的。示意图如下:
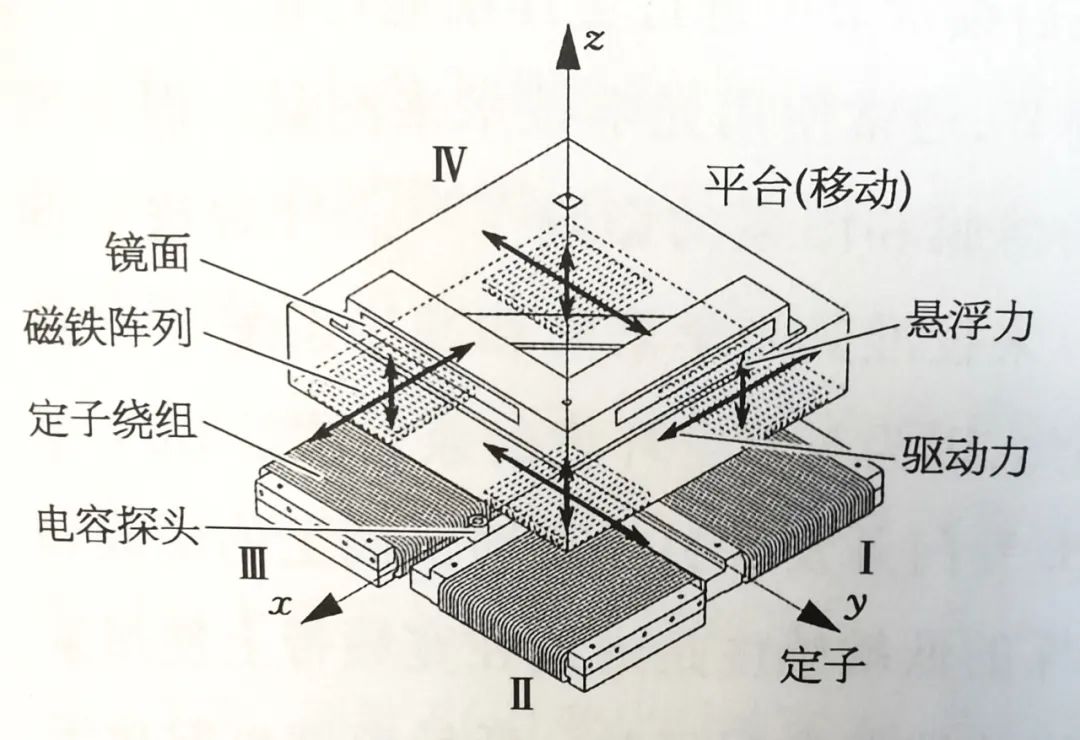
磁体阵列通常采用Halbach结构,在阵列的一侧产生强磁场,另一侧产生非常弱的磁场。
© 滤波器 微信公众号

