上一篇中提到:相移掩模、光学邻近效应校正、离轴照明等方法能弥补光学曝光的不足,但人们也在寻找新的曝光方法来完成纳米级的集成电路制造。本文详细介绍其中的电子束曝光、X射线曝光、离子束曝光分别的原理和优势劣势,以及应用场景。
本文目录:
电子束
X射线
离子束
电子束
电子束(e-beam)曝光是利用某些高分子聚合物对电子敏感而形成曝光图形的。光学曝光的分辨率受到光波长的限制,光波长经历了从G线到I线、深紫外、极紫外的波长不断缩短的发展过程。电子本身是一种带电粒子,根据波粒二象性也可以得到电子的波长:100eV的电子其波长只有0.12nm。
下图为电子束曝光系统示意图:
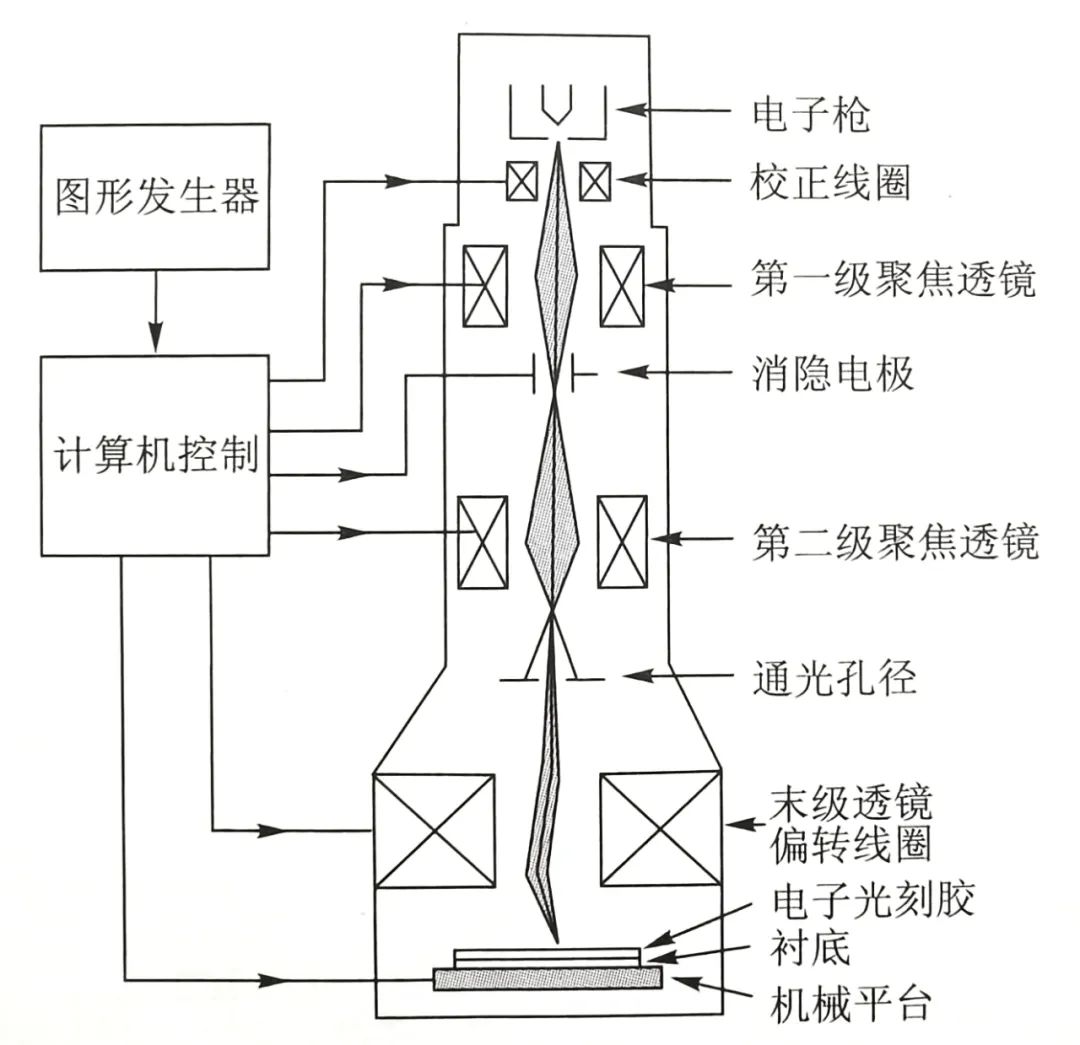
电子枪:产生具有适当电流密度电子束的部件,钨丝热发射阴极或六硼化镧(LaBs)单晶可以用作电子枪。
聚焦透镜:使电子束聚焦成直径为10~25 nm的束斑。
消隐电极:用于电子束的通断。
通光孔径:用来对束张角加以限制。电子透镜的像差主要是球差,而球差与束张角3次方成正比。限制束张角可以提高系统的分辨率。
电子束偏转线圈:工作频率较高(MHz或更高),可使聚焦电子束在衬底上对准扫描场内的任何位置。偏转器可以是静电的或磁的,磁偏转像差和畸变小,但速度慢。静电偏转速度快,但像差大。
由于聚焦电子束扫描场(一般为1cm)远远小于晶圆的直径,因此需要用精密机械工作台对晶圆定位以便于曝光图形。
电子束曝光的优点和应用:
电子束曝光可以直接在抗蚀层写出图形,不需要掩膜。电子束直写的灵活性和高分辨率使它成为当今微纳米科学研究与技术开发的重要工具。利用现代电子束曝光设备和特殊的抗蚀剂工艺已经能够制作小于5nm的精细结构。
电子束曝光也是制作掩膜的主要工具之一,现在已经成了制作极紫外(EUV)曝光掩膜的唯一工具。
缺点:
1.电子束曝光机的产出率低。在分辨率小于0.25μm时,每小时只能加工10片左右的晶圆。MAPPER公司的新款电子束曝光,有65000根独立的电子束,产能为450片/每月(注意单位是月)。作为对比,ASML的极紫外光刻EUV的产能为:型号3400C产能为每小时135~170片,最新型号3600D的产能相对3400C又提高了15%~20%,每小时大于160片。

图源:MAPPER官网

EUV系统 图源:ASML官网
分辨率的限制:
电子邻近效应:如同光学曝光中光波在光刻胶中的吸收一样,电子束曝光也是通过抗蚀剂聚合物分子对电子能量的吸收实现的。经过曝光机电子光柱加速的电子入射进入抗蚀剂材料后会与抗蚀剂超材料的原子碰撞而产生散射。如果相邻的两个曝光图形靠得非常近,则由于电子散射形成的曝光能量分布将会延伸到相邻的图形区域内,使曝光图形发生畸变。
2. X射线
X射线曝光与光学曝光本质上的区别在于X射线能够穿透大部分物质,只有高原子序数的材料能够吸收X射线。因此,曝光掩膜的形式与光学曝光不同。X射线无法像光波那样被聚焦,因为X射线在所有材料中的折射率都接近1。因此X射线只能用作1:1邻近式曝光,不能做缩小式曝光。
如图所示。X射线的波长大约为1nm,掩模的位置距离晶圆10~40μm。由于X射线的吸收强度与材料的原子序数有关,且1nm时大多数材料具有较低的透射度,因此掩模衬底必须是由原子序数小的材料(例如碳化硅或硅)做成的薄膜片(厚度为1~2μm)。掩模衬底上涂覆很薄(约0.5μm)的原子序数大的材料(如钜、钨、金或它们的合金)做成薄膜,图形本身就做在这层薄膜上。
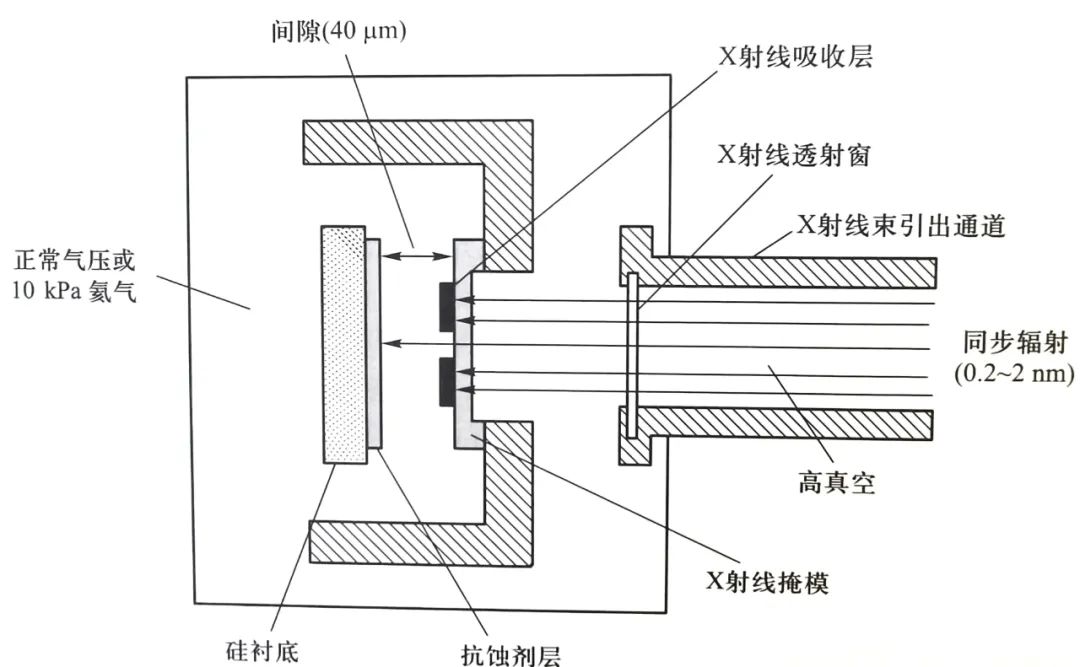
为避免光源和掩模之间的X射线吸收,曝光一般在氦气环境中进行。X射线在真空中产生,由一个很薄的真空窗口(通常为铍)与氦气环境隔离。掩模衬底会吸收25%~35%的入射光通量,因此必须进行冷却。1 μm厚的X射线光刻胶要吸收10%左右的入射光通量。衬底没有反射,不会形成驻波,所以不需要抗反射镀层。
光源由同步辐射加速器产生。尽管X射线波长很短,但是能量很高,它会在光刻胶中激发高能的光电子,而光电子本身携带X射线所具有的的能量,能量很高,它会在光刻胶里继续以一定速度散射,且散射没有方向性。
X射线的优势:
衍射效应很小。
具有垂直侧壁的非常精细的特征(垂直侧壁斜度 < 1μm/mm)
焦深非常大,可以实现非常高的纵横比(高度:宽度> 100:1)结构。
对灰尘和颗粒相对不敏感。
X射线的难点和分辨率的限制:
1.掩膜制造困难:掩膜是1:1的,任何掩膜缺陷都会造成成像面上的缺陷。掩膜上的金属沉积层的应力和掩膜支撑结构的应力都会造成掩膜图形畸变。
2.掩膜与硅片的间隙需要精确控制:太近会损坏掩膜,太远会降低分辨率。为了控制整个间隙距离的一致,要求硅片平整度在±0.25μm以内,掩膜的平整度在±0.5μm以内。
3.高能X射线产生大量光电子和俄歇电子,这些低能电子会对光刻胶产生曝光作用,而且他们在光刻胶中会产生一定范围内的散射,扩大X射线的曝光范围,使实际的分辨率降低。
4.X射线曝光还存在衍射效应,对于相干性好的X射线,这种效应尤其明显。由同步辐射加速器发出的X射线的相干性尤其好。
5.分辨率仍然受到菲涅耳衍射限制。菲涅尔衍射引起的分辨率极限:

g:间隙; t:光刻胶厚度。
例如:100nm特征尺寸要求λ=1nm,g=4.4μm。
6.需要的同步辐射光源非常庞大并且昂贵。
怎么提高分辨率:
1.使用更长的波长(例如1nm)来减少光电子横向扩散。
2.更长的波长也意味着更薄的金吸收体,可以精确地图案化。(厚金可能没有垂直侧壁,导致边缘模糊。)
3.使用更小的间隙和更薄的光刻胶。较薄的光刻胶有利于具有较小穿透深度(更多吸收)的较长波长。
由于上述的各种因素,X射线分辨率很难降低到50nm以下,实验室获得的最小图形尺寸在30nm左右
X射线的应用:
1.由于焦深大,可实现非常高的纵横比,可应用于MEMS(微机电系统)和传统精密制造。

加速度传感器
3. 离子束
离子束与电子束的区别在于他们的质量,最轻的离子如氢离子也是电子质量的1840倍。
离子源:
液态金属离子源(LMIS)是利用液态金属在强电场作用下产生场致离子发射所形成的的离子源。LMIS最早是以镓为发射材料,目前仍是应用最普遍的离子源。
气体场离子源(GFIS)是通过高电场使气体原子电离形成的离子源。氦离子GFIS是最早开发的气体离子源,后来又出现了氢气、氖气、氮气等。下图为蔡司的Orion NanoFab聚焦离子束系统:
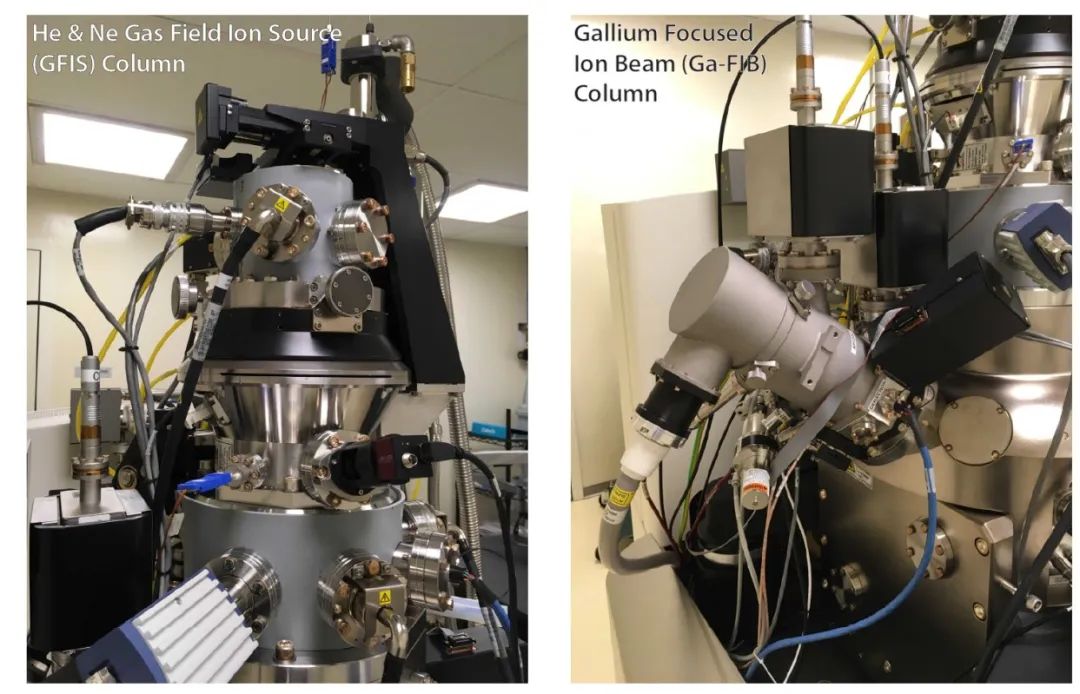
左:氦/氖场离子源柱 右:镓聚焦离子束柱
图源:lab.kni.caltech.edu
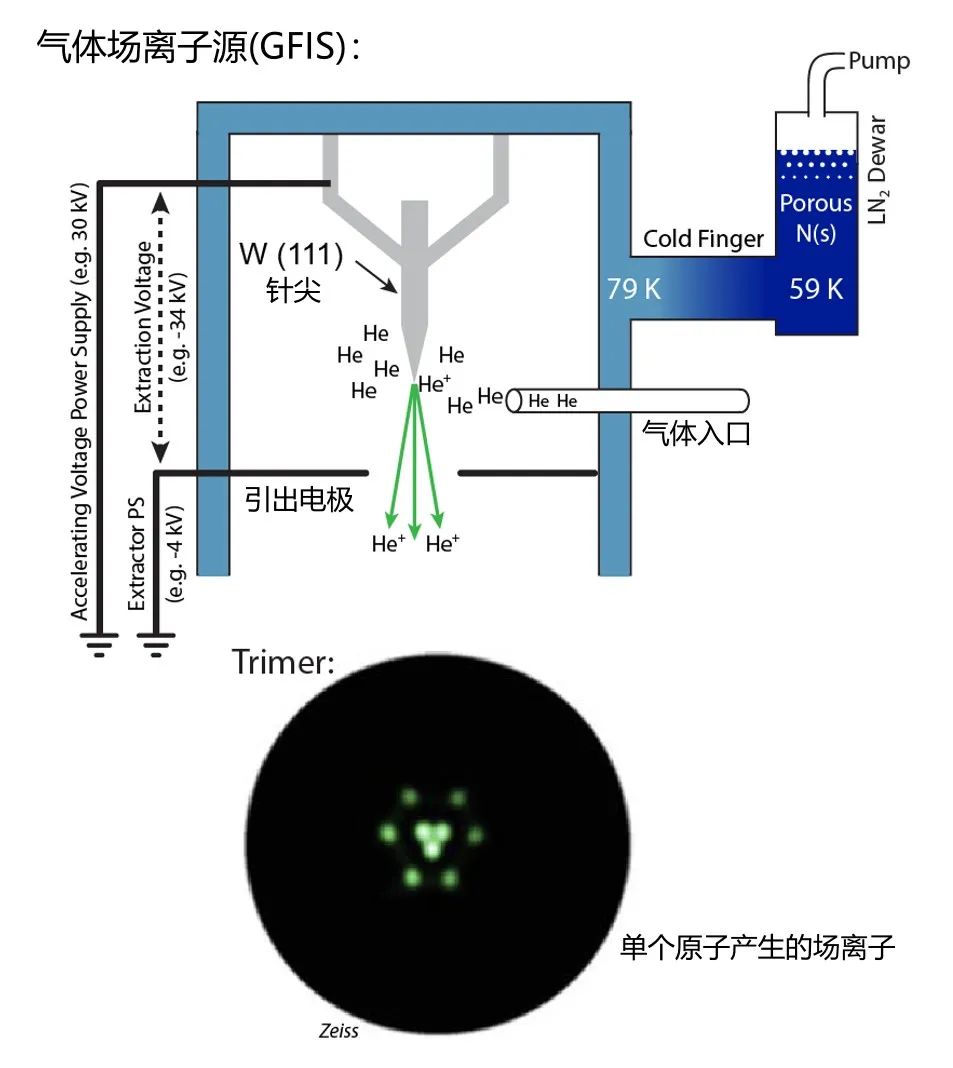
图源:lab.kni.caltech.edu
聚焦离子束曝光:
聚焦离子束系统从本质上与电子束曝光系统没什么差别,都是由电子或离子发射源、电子或离子光柱、工作台、真空与控制系统组成。

图源:lab.kni.caltech.edu
优点:
离子束曝光有非常高的灵敏,因为离子在固体材料中的转移能量的效率远远高于电子。离子束曝光的另一个优点是几乎没有邻近效应:由于离子本身的质量远大于电子,离子在抗蚀剂中的散射范围要远小于电子,并且几乎没有背散射效应。
难点:
1.由液态金属离子源(LMIS)发射的离子具有较大的能量分散,主要是空间电荷效应引起的:空间电荷效应是指带电粒子因携带相同电荷而互相排斥的效应。这种相互排斥与带电粒子速度成反比。离子质量远大于电子,同样电压下,速度要低得多,所以镓离子比电子的空间电荷效应大350倍。
但是相比下,气体场离子源(GFIS)有极小的发射角和极低的能量分散,因而可以有极高的分辨率。
2.离子穿透深度太小。增加离子穿透深度的办法是增加离子能量或者采用轻质量离子。气体场离子源GFIS(氦离子、氖离子等)的发展使原来聚焦镓离子束曝光存在的问题得到解决。
电子束曝光与聚焦氦离子束曝光进行对比:
康奈尔大学Matthew Fu等人曾基于蔡司的聚焦离子束系统Orion NanoFab做过对比测试:
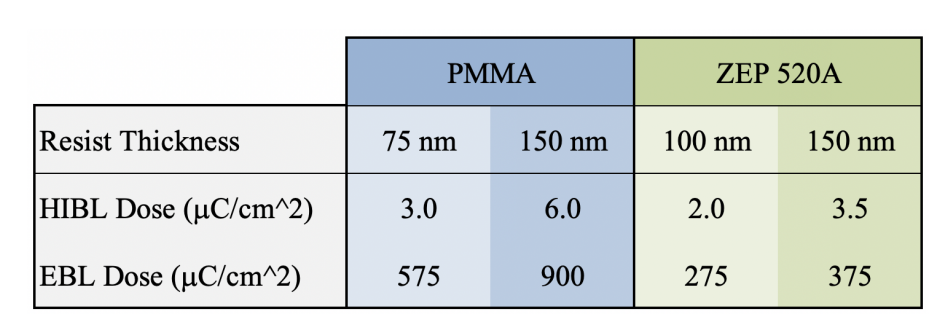
数据和图源:lab.kni.caltech.edu
该表显示了使用氦离子束光刻 HIBL 和电子束光刻 EBL 在不同光刻胶(抗蚀剂)厚度下曝光 PMMA 和 ZEP 520A 所需的曝光度。总体趋势是氦离子束光刻HIBL 所需的曝光度比电子束光刻EBL 低大约两个数量级。
说明氦离子束曝光相对电子束曝光是有优势的。
即便如此,对比于EUV极紫外光刻,离子束曝光的产能还是太低。
总结:电子束曝光、X射线曝光、离子束曝光各有优劣势,并且根据自己的特点各有对应的应用场景,但在光刻方向上,目前这几种曝光方式都与EUV极紫外光刻有巨大差距。
下一篇将单独介绍EUV极紫外光刻。
© 滤波器 微信公众号

