引言 ▶▶▶
现代汽车中越来越多的电子功能必须在给定(和受限)空间内实现。这导致印刷电路板上的器件密度不断增加。为解决板级器件密度问题,必须缩小所用电子器件的尺寸。与此同时,更小的封装需要在更小的管脚尺寸内耗散相同的热量,从而提高了板上功率密度。
双侧扁平无引脚(DFN)封装是一系列非常小的现代化无引脚表面贴装塑料封装,可替代庞大的有引脚表面贴装封装。本应用笔记介绍了汽车 DFN 封装较之于对等的有引脚封装的散热能力,以及高功率密度封装所需的散热管理。
封装概念
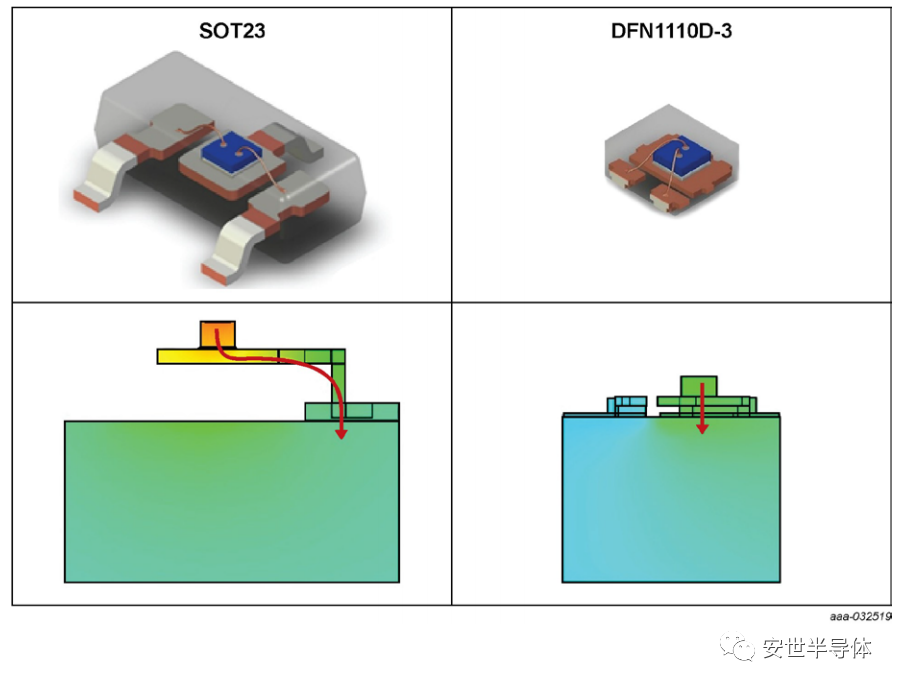
图 1. SOT23 与 DFN1110D-3 中热流的热模拟比较
几十年来,有引脚 SMD 封装一直都是分立式电子器件的行业标准。SOT23 可能是世界上最著名的 SMD 封装,其结构如图 1 所示。图中芯片置于引脚框架上,与金属焊盘一起采用复合模具完全封装。主要的热传输机制为热传导,因为在给定结构和温度范围内,热对流与辐射几乎无关紧要。产生的热量通过芯片贴片层传导至引脚框架中,然后从引脚框架流经长引脚进入 PCB。图 1 中的热模拟显示了 SOT23 封装器件沿引脚框架并穿过封装中间部分的横截面,突出显示了热通道。
作为 Nexperia(安世半导体)用于代替 SOT23 的 DFN 封装,DFN1110D-3 没有引脚。由于没有引脚,且焊线长度更短,DFN 封装的寄生电感比对等的有引脚封装更小。金属焊盘更紧凑,且更靠近引脚框架。这样可以大大减小封装尺寸,同时在芯片下仍采用相同大小的引脚框架。引脚框架可有效地作为封装底部的 外露散热器和电触点,从而使热量直接从芯片流向 PCB,如图 1 中的热模拟所示。正因如此,尽管 DFN 封装尺寸非常紧凑,但仍具有出色的功耗能力。

图 2. SOT23 和 DFN2020D-3 上的红外测量
为充分利用 DFN 封装,必须使用具有低热阻和足够导热性的 PCB,以实现适当的横向散热。热量直接通过外露散热器进入 PCB,并通过 PCB 上的更小面积传输。高功率密度如图 2 中的红外图所示,显示了功耗相同(250 mW)的 SOT23 和 DFN2020D-3 之间的比较。显然,DFN2020D-3 具有较高的功率密度和良好的散热性能,尤其是封装上没有白点。
Nexperia 汽车 DFN 封装系列
表 1 概述了供应的 DFN 封装及其对等的有引脚封装。此外,它还列出了转为使用 DFN 封装后可能节省的空间。节省的空间是根据建议用于回流焊的管脚尺寸计算得出的。该表并不意味着在无深入热传导的情况下使用 DFN 封装一对一替代有引脚封装。DFN 封装的散热性能以及一些精选的 DFN 封装与其对等的有引脚封装的散热性能比较将在下一段进行讨论。
表 1. Nexperia 的汽车 DFN 封装系列

散热性能
表 2 总结了针对不同的 PCB 类型和设置,在结温与作为热接地的环境温度之间测得的典型热阻。用于计算 Ptot值的 ΔT 为 125 k(环境温度为 25°C,最大结温为 150°C)。在下面的段落中,我们将讨论一些封装的散热性能,并与对等的有引脚封装进行比较。在以下比较中,有引脚封装和 DFN 封装的芯片尺寸相同,因此可以排除芯片尺寸对散热性能差异的影响。
表 2. Nexperia 的汽车 DFN 封装系列

[1] R
DFN1110D-3 与 SOT23 比较
如表 2 所示,根据 310 K/W 的 R
在模拟中,假设功耗为 250 mW,这样 SOT23 的结温则为 130℃,DFN1110D-3 为 115℃。在功耗给定的情况下,DFN 封装中较低的芯片结温还可用作为额外的余量,以防由于特定应用的可靠性标准而要求降低最大结温。因此,器件的运行温度低很多,同时还可以节省大量的 PCB 空间。由于前面提到 的外露散热器可以将热功率直接传入 PCB 中,因此 DFN1110D-3 具有出色的散热性能。
如表 2 中所示,增加的 1 cm

图 3. SOT23 和 DFN1110D-3 的散热性能
图 3:DFN1110D-3(右)与 SOT23(左)的散热性能模拟。模拟设置:FR4 PCB,采用 35 µm 厚铜 线路,标准管脚尺寸,T
DFN1608D-2 与 SOD123 比较
双引脚 DFN1608D-2 封装的主体尺寸为 1.28 mm
表 3. Nexperia 的汽车 DFN 封装系列

表 3:20V 2A NPN BJT 在三种不同封装中的比较:SOT223、SOT89 和 DFN2020D-3。根据不同 PCB 设置下测得的 R
与带有大型散热器的有引脚封装进行比较
尽管与对等的有引脚封装相比节省了大量空间,但两个重点介绍的 DFN 封装都具有出色的散热性能。这是因为外露散热器使得所述热流可直接进入 PCB 中。接下来的问题是,DFN 封装与带有大型散热器的较大有引脚封装(如 SOT223 和 SOT89)比较起来如何。
表 3 显示了 20 V 2A NPN 晶体管在 3 中不同封装中测得的 R
使用 4 层 FR4 PCB 和 1 cm
表 4. 结点与焊点之间的最大热阻

总结
DFN 封装尺寸紧凑,适用于替代 PCB 上体积庞大的有引脚封装。高密度的 PCB 意味着功率密度也更 高,这就要求封装具有出色的散热能力。DFN 封装采用外露散热器,且热通道经过优化,因此可满足这一要求。建议使用导热性更高的 PCB 类型,以充分利用 DFN 封装的优势。
即使是在采用标准管脚尺寸的标准 FR4 板上,小型 DFN 封装(如 DFN1110D-3 和 DFN1412D-3)的 Ptot 值也比其对等的有引脚封装更高,同时仍可节省大量 PCB 板空间。然而,就连 SOT223 和 SOT89 这样带有大型散热器的超大有引脚封装,也可以使用 DFN2020D-3 代替。在这种情况下,需要在标准 FR4 PCB 上采用 1 cm


