
12月16日电,芯榜记者从今日举办的“第二届中国互连技术与产业大会”上获悉,首个由中国集成电路领域相关企业和专家共同主导制定的《小芯片接口总线技术要求》团体标准正式通过工信部中国电子工业标准化技术协会的审定并发布。据悉,这是中国首个原生Chiplet技术标准。
第二届中国互连技术与产业大会上,长电科技总部研发林耀剑先生分享了“Chiplet封装技术探讨”的主题报告

Chiplet共生于3D SoC和异构SiP
基板上的SiP与芯片上SoC的竞争与交替促进发展,最终在产品上的采用仍然取决于多种因素,特别是成本、供应链上高端硅节二点设备和工艺能力,总体交付和性能之间的平衡。
而chiplet是介于基板上的SiP与芯片上SoC的交互范围。
1、如果chiplet被集成于有机基板与重布线或2.5D封装之中,其本质上可以归属于siP。
2、如果chiplet 被异质直接键合集成于硅芯片及其无机介质中,那么其本质上可以归属于SoC,是2.5D或3D SoC。
3、而如果是Chiplet再与2.5D/3D SoC集成于有机基板或2.5D封装之中,其本质上仍可以归属于SiP。
具体采用哪种结构和方法, 完全取决于器件商或终端的总体评估和决定。
1) 2018年10月总部研发总体负责与客户启动共同研发以RDL First为基础的高密度扇出型多芯片Fan-out FCBGA平台技术(统筹协调长电先进和长电星科金朋江阴的技术力量)。相关技术具备大尺寸(30x20mm 扇出封装,~67.5x67. .5mm fcBGA-SiP) , 2um线宽距和3层重布线, 40um的微凸点高密度倒装键合及2-3粒10x17mm 7nm芯片集成)2) 2020年JCAP将其中的高密度 扇出型封装技术、关键大员和设备转移到长电绍兴分公司,并与长电星科金朋江阴一起实现产品小量产及后续多个产品的大量产。3) 2021 突破FO- Interposer MCM的chiplet封装技术,并进入量产。4) 2022年突破带2.5D Si Interposer MEM的大尺寸fcBGA技术,并进入小量产。5) 2022年加大FO-RFI/EDI-MCM的投资 ,同时在前期8”IPD TSV和12" TSV MEOL封装技术的研发积累上对2.5DSi Interposer (Si-TSI-MCM) 的MEOL晶圆级技术进行投资,特别是在江阴投资建立长电微电子。6)具备完整的高端chiplet封装设计研发和大量产经验的封测服务集团。长电科技早期的25D与扇出型技术积累和研发量产经验,(结合国内10多年的完整fcBGA技术和大量产经验,对于后续的深入创新开发和客户的具体产品合作开发会有极大的帮助。能够有效地协调资源以服务客户。
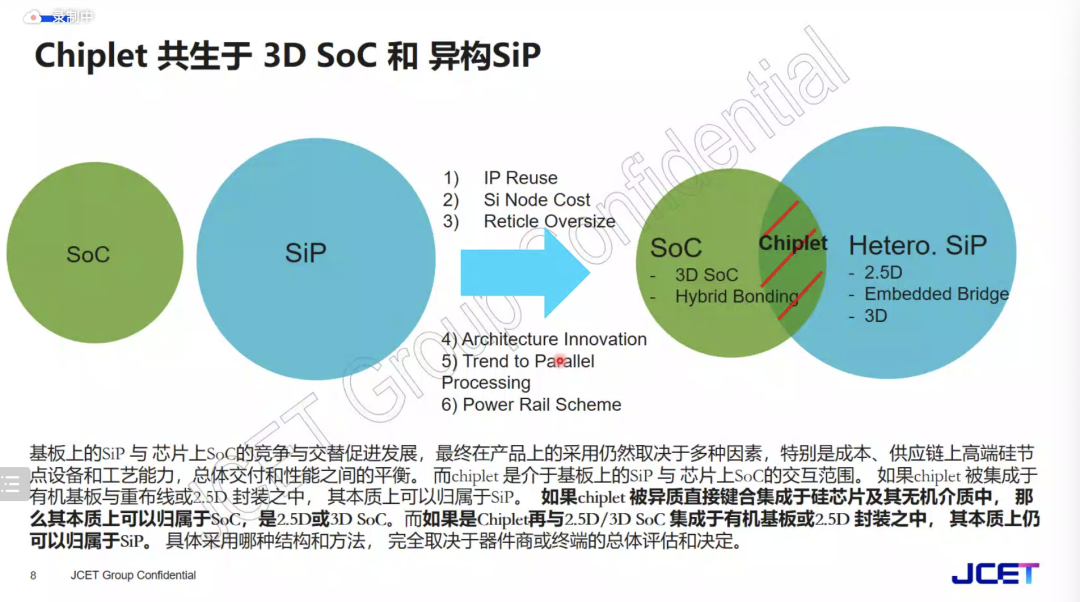

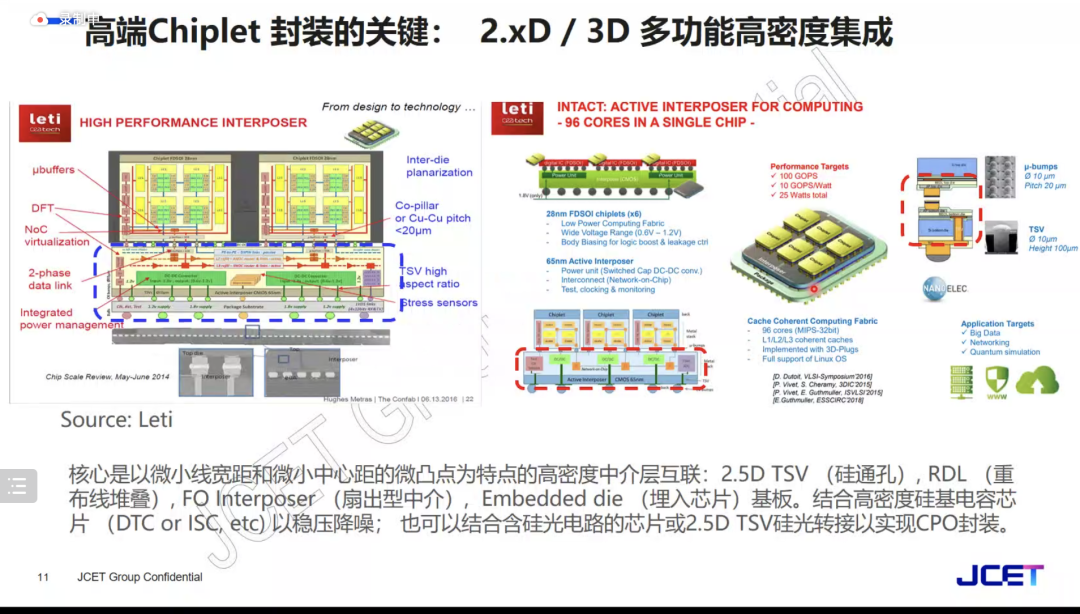
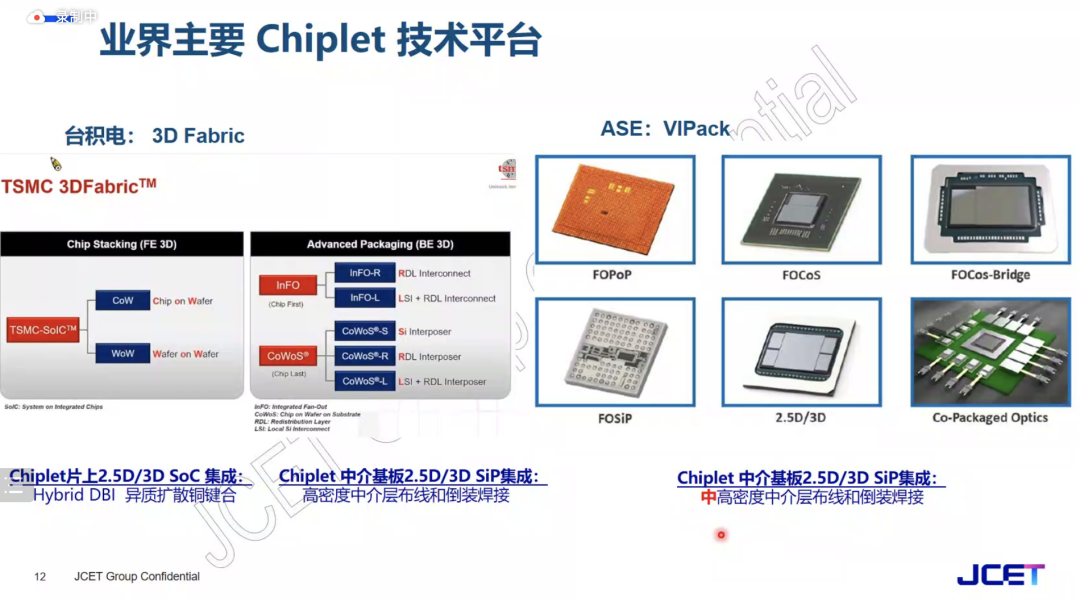


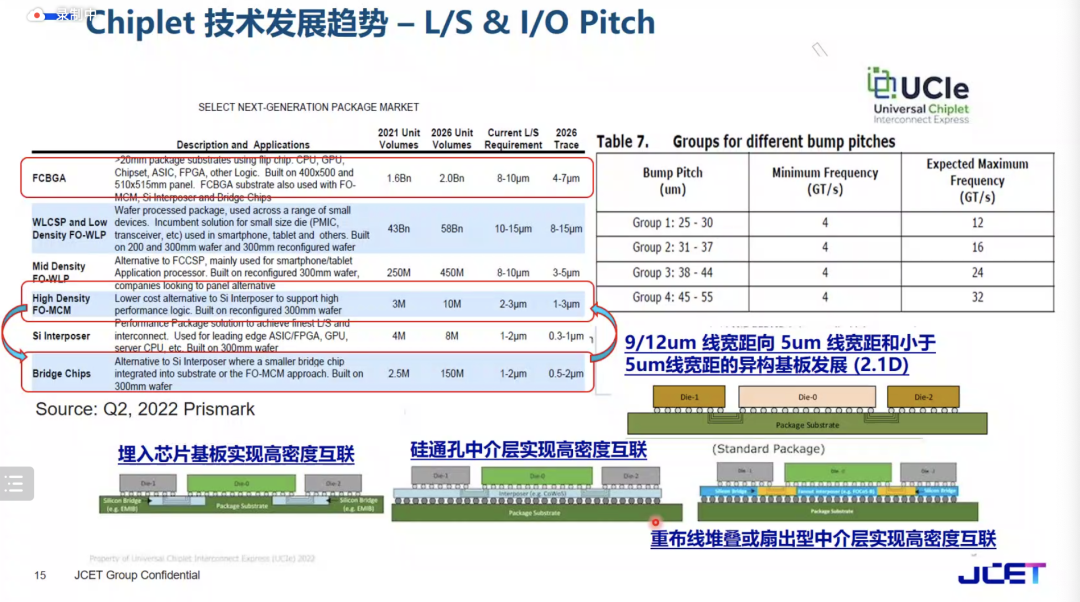
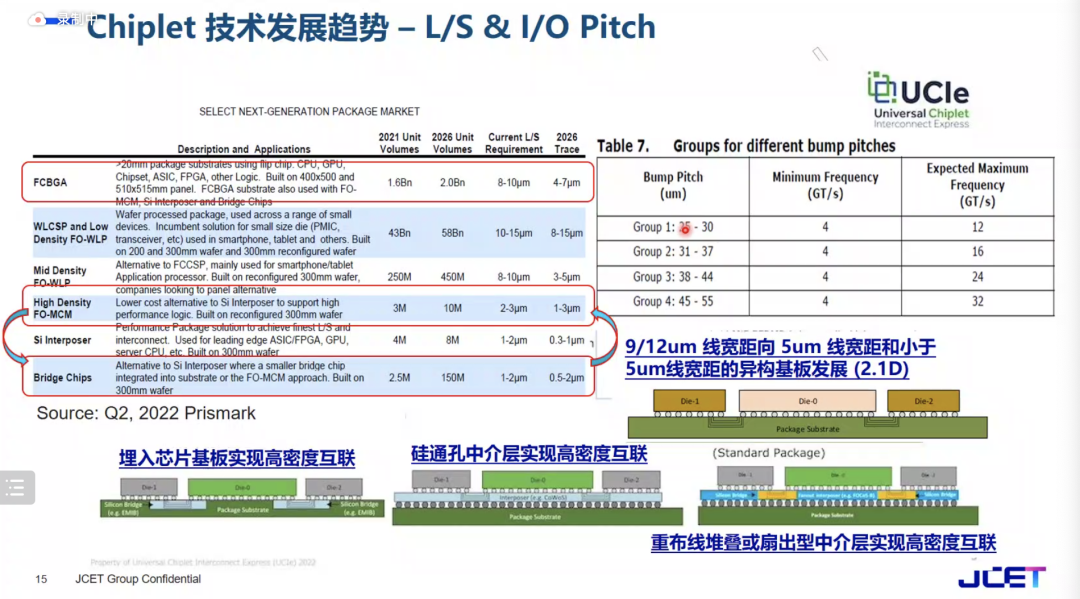
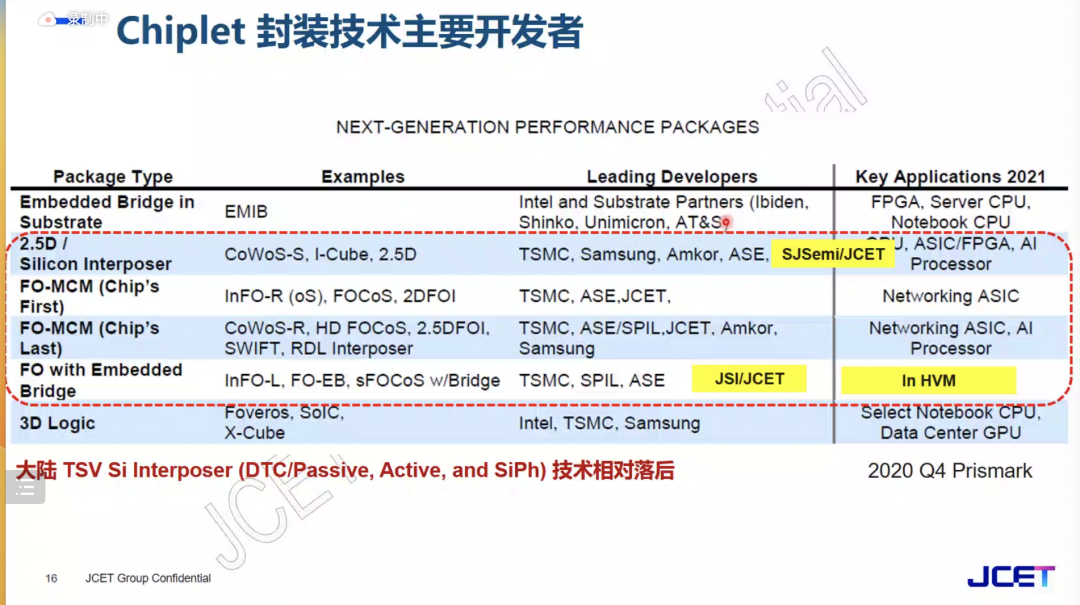
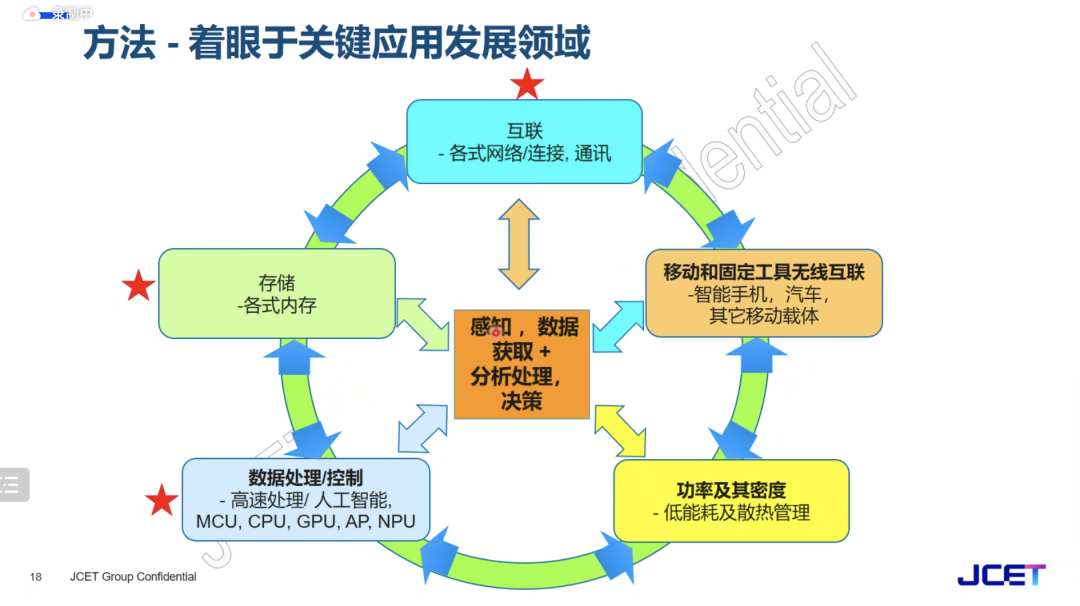
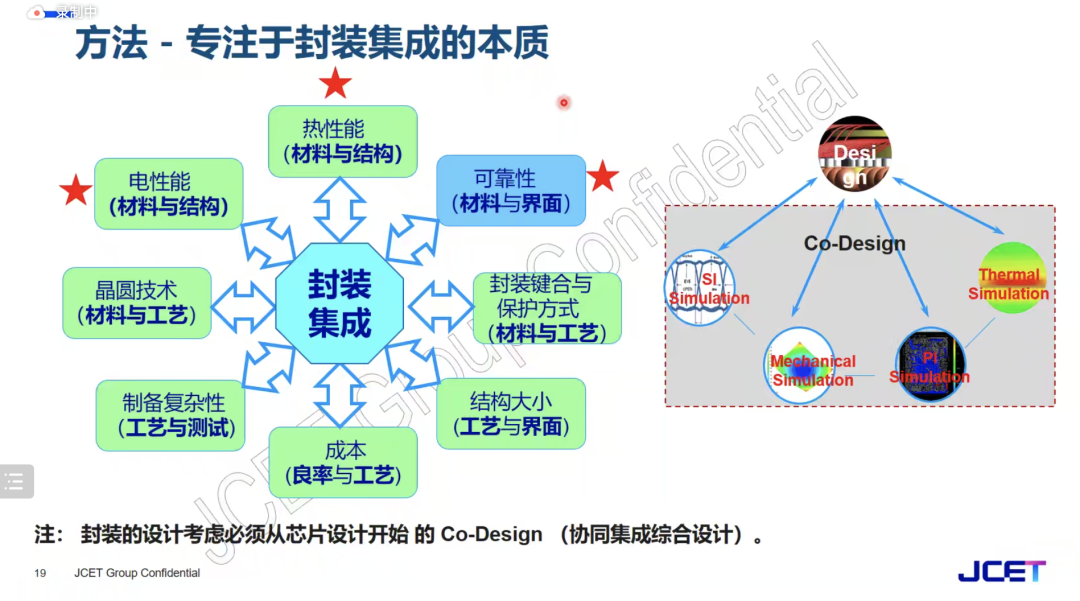
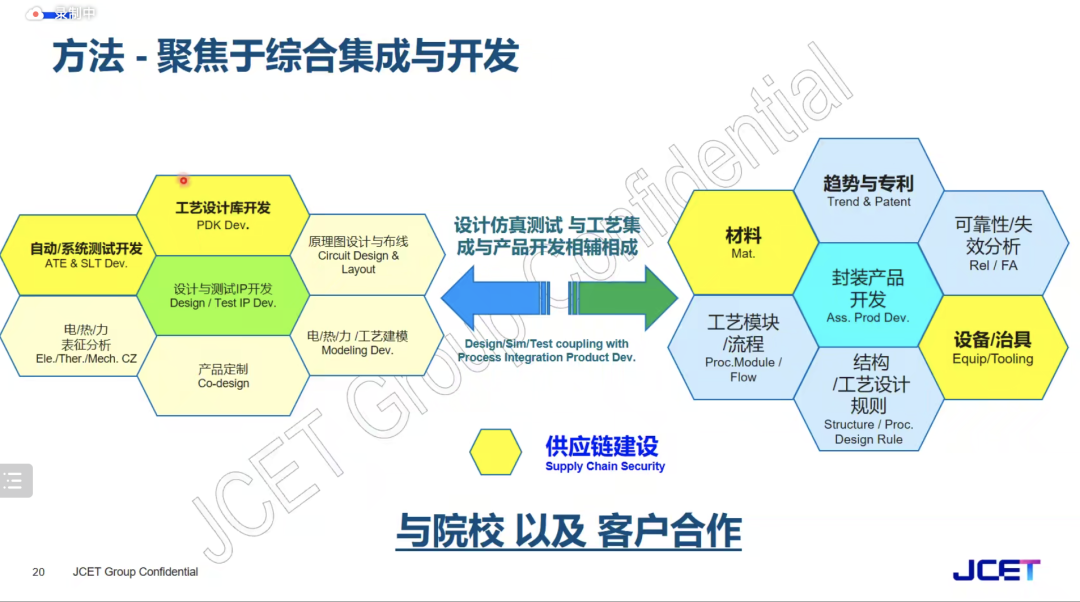
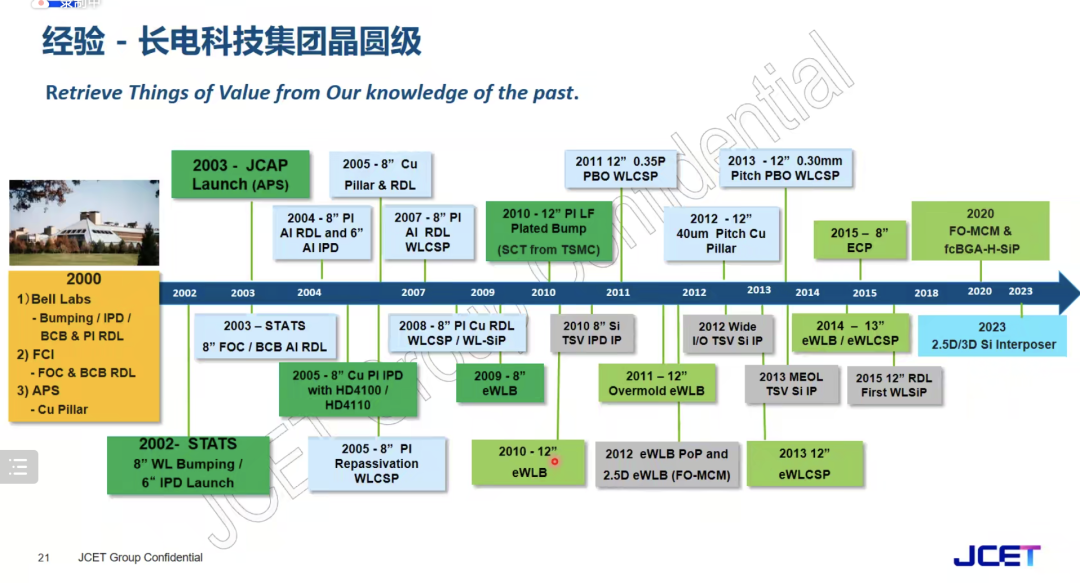
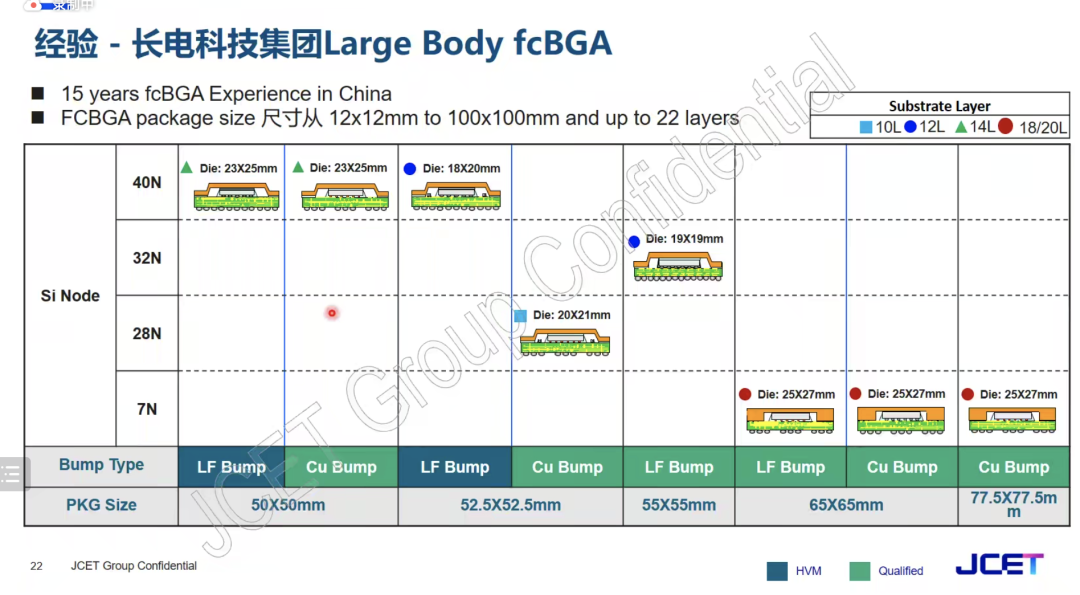

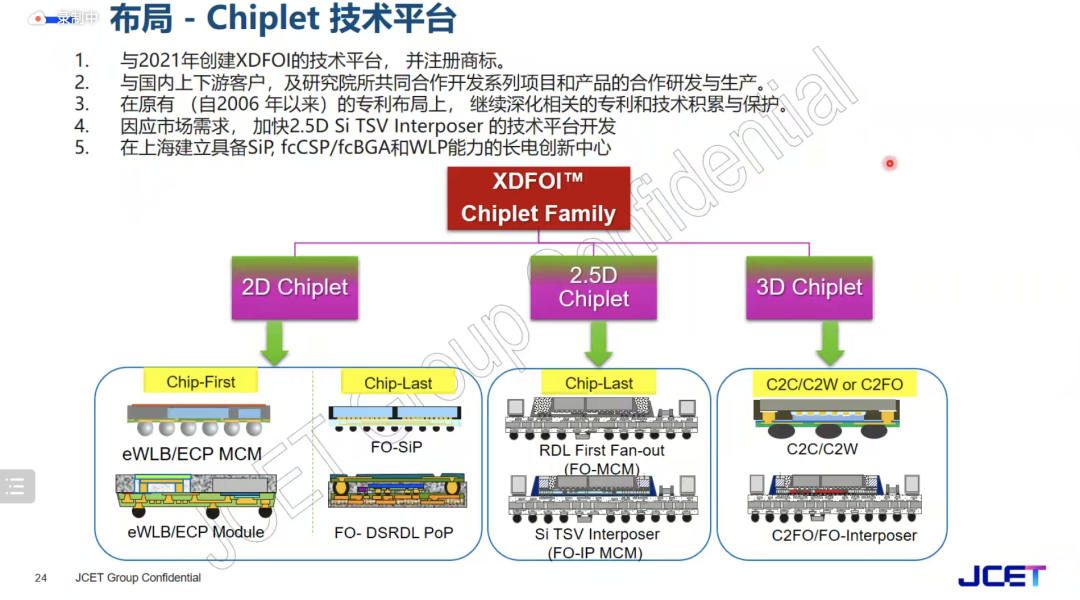
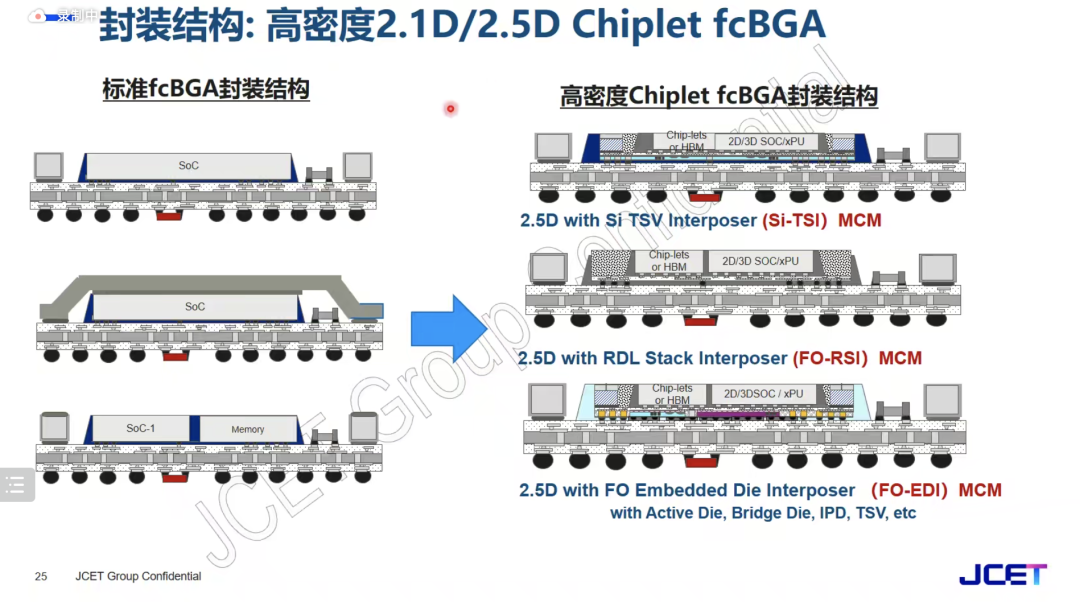
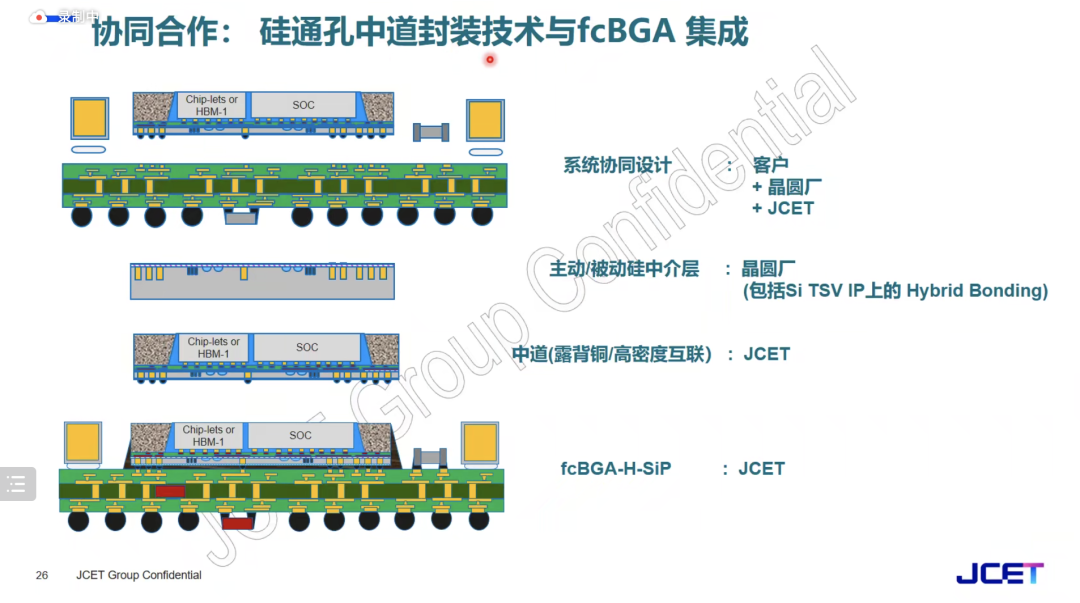
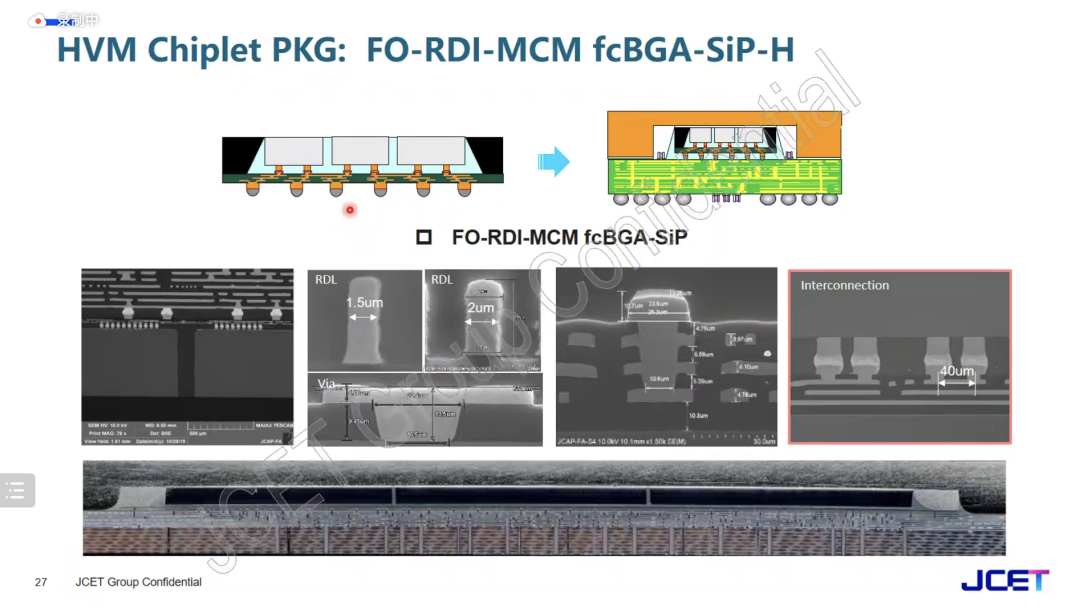
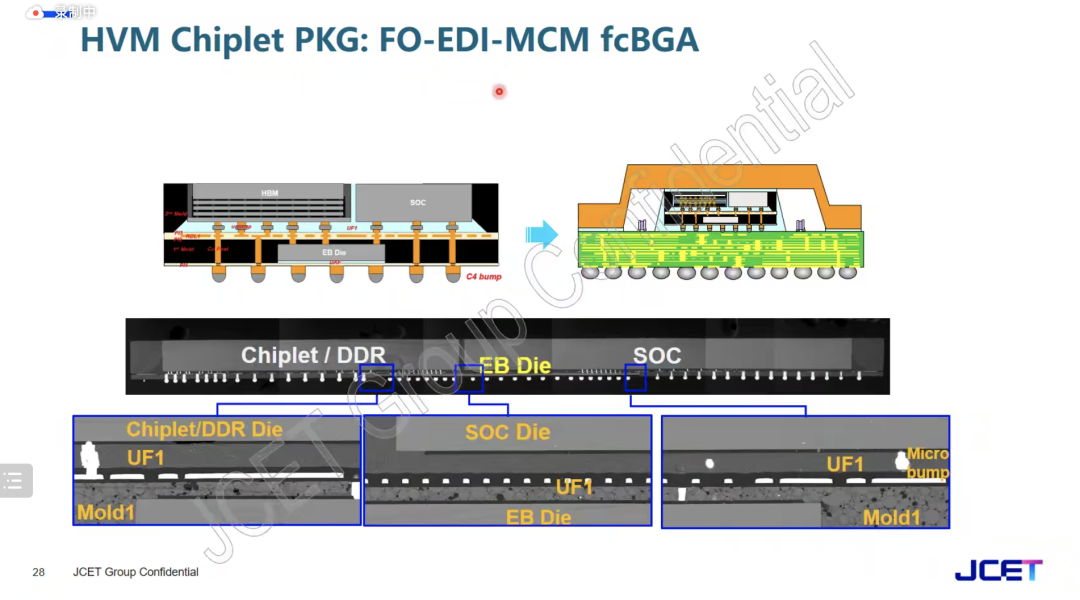
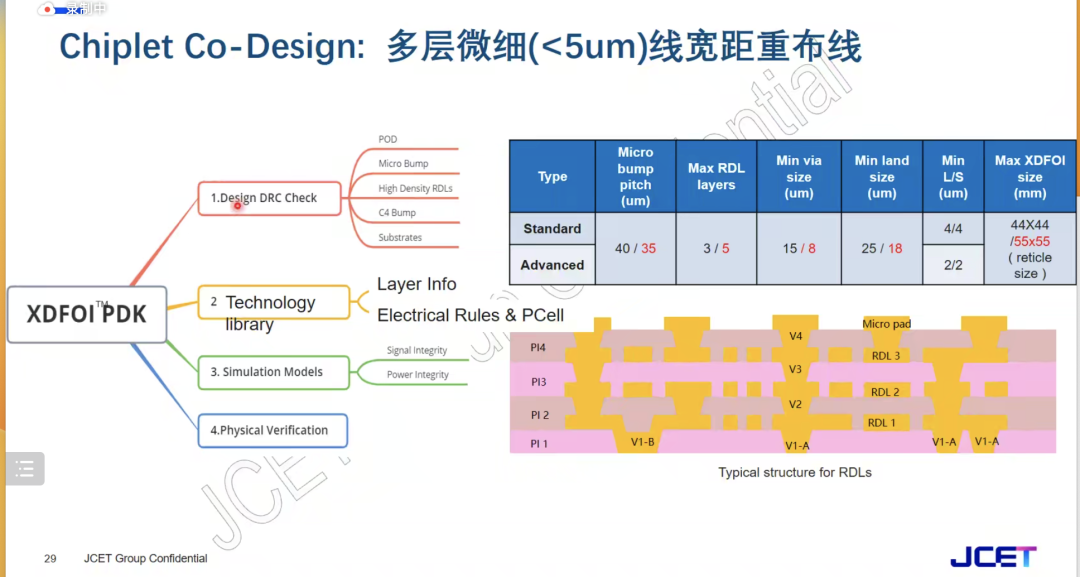
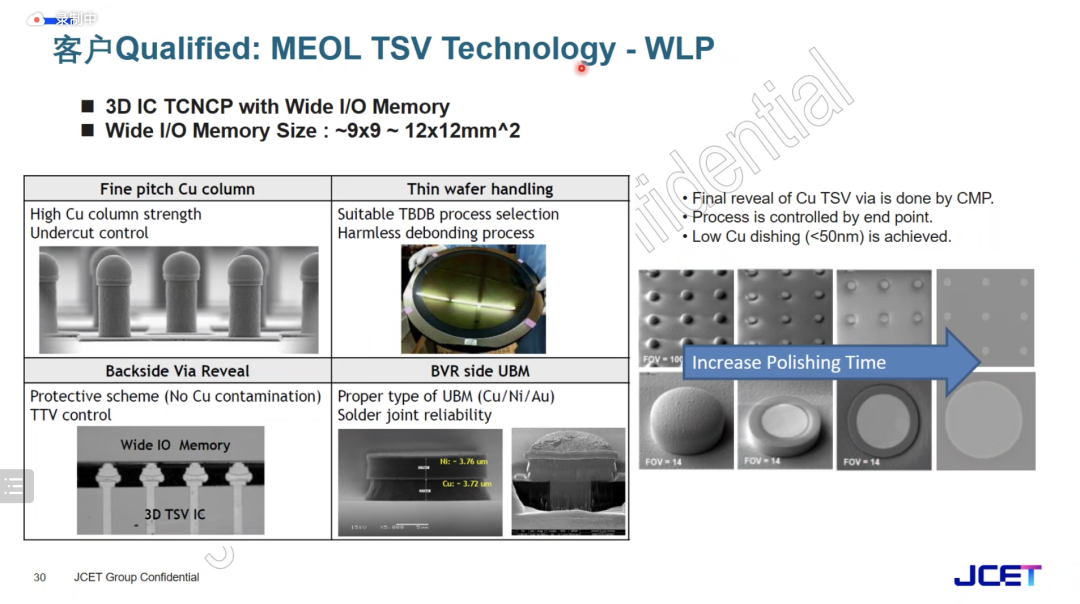


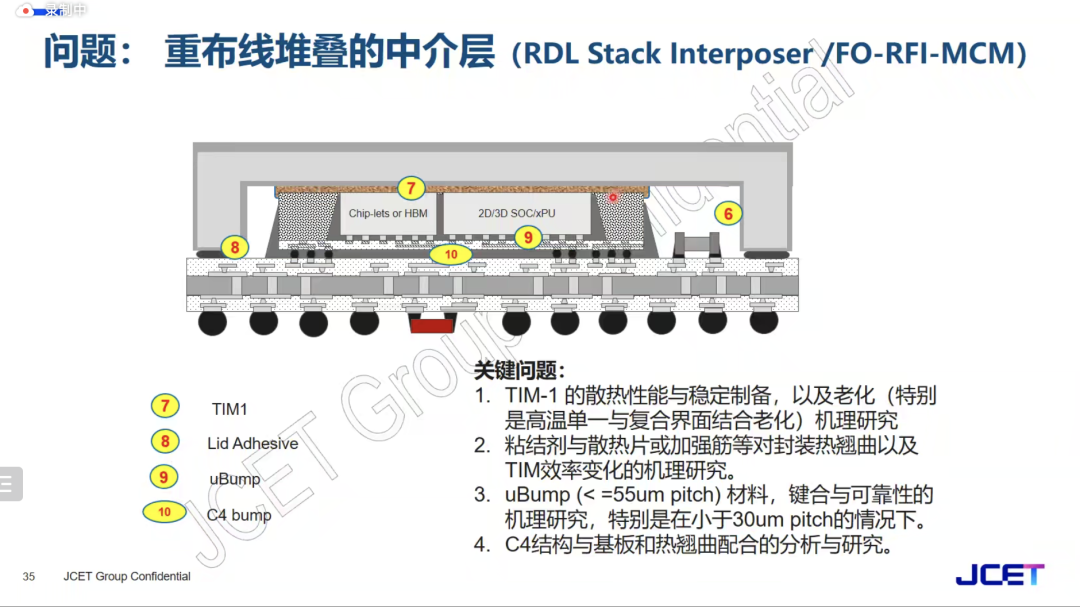
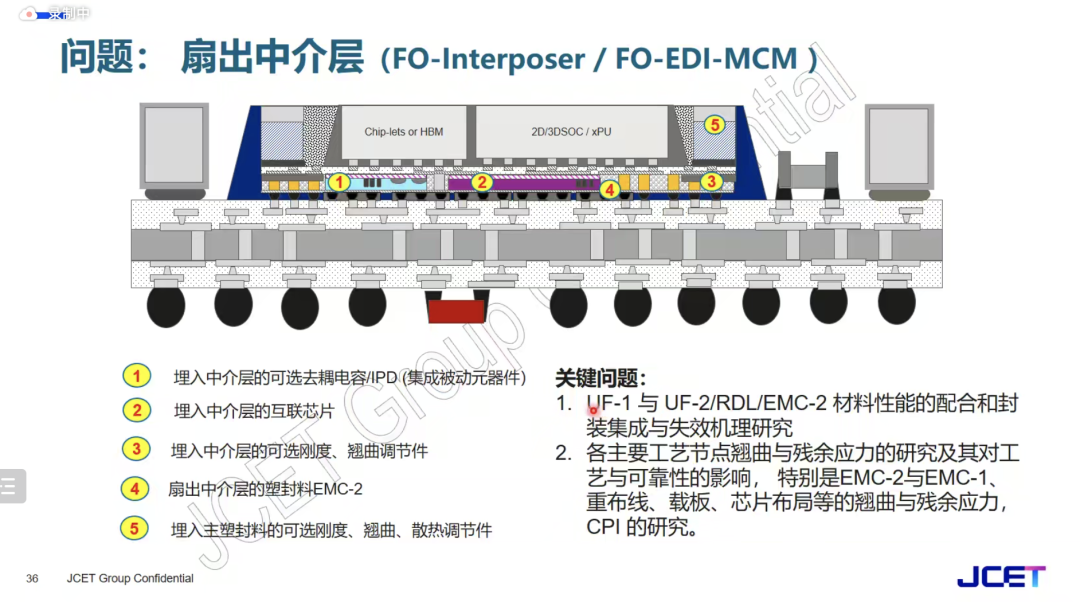
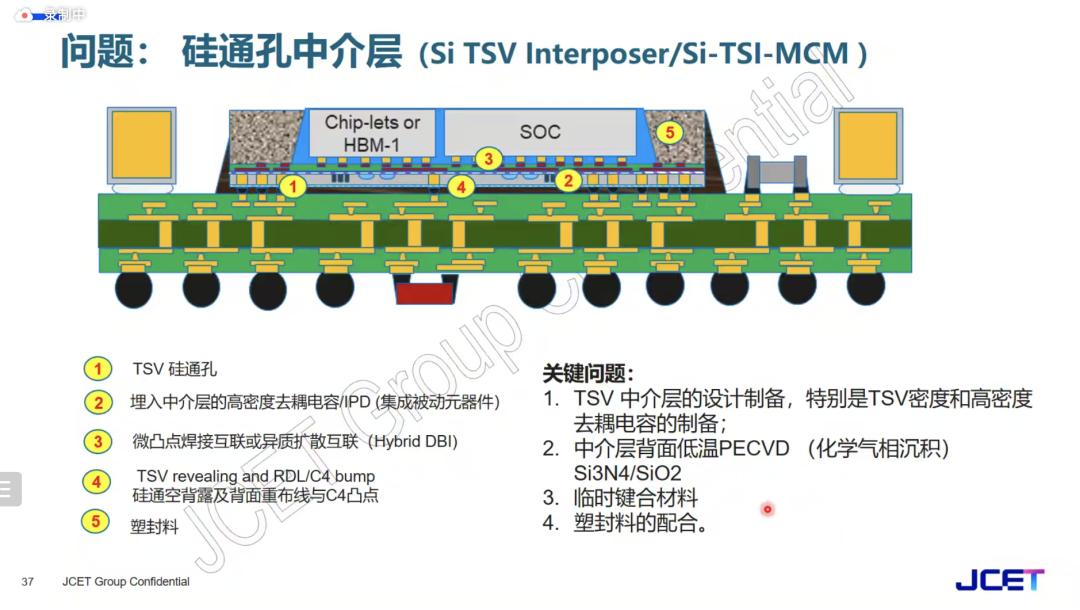

➢鼓励学校和科研院所与上下游(设计,芯片制造和封装)企业合作,建立动态的联合研发体。2、上下游企业有海量的动态与静态数据没有利用和整理分析研究, 相关的研究和理论较容易验证和完善。3、学校和科研院所针对关键基础机理、材料和结构界面进行研究。企业提供关键验证数据以帮助完善研究和建模,然后再反哺企业提升工程研发效率, 并引导关键材料和关键检测仪器的开发。4、建立分享的大型仿真工作站或超算中心(Cloud Computing Center),以帮助提升预测模型的准确性和仿真的速度。5、合理收费和互助,考虑建立Credit 和积分制度。----全文到此为止,如果喜欢,请点下“在看”或分享到朋友圈。
1、2022 中国封测厂 TOP50 (更新版)
2、国产GPU企业大盘点(20家)
3、中国MCU企业大盘点(50家)
4、台积电:十大客户!
5、年被人嘲笑的上海,如今撑起中国芯片的半边天!
6、一个亿,在一家芯片公司可以烧多久?