近日,日立公司宣布成功开发出一项高灵敏度半导体缺陷检测技术,能够利用机器学习算法检测10nm及更小尺寸的微缺陷。这项创新技术在2月末的SPIE先进光刻与图案化2025学术会议中首次亮相,吸引了业界的广泛关注。
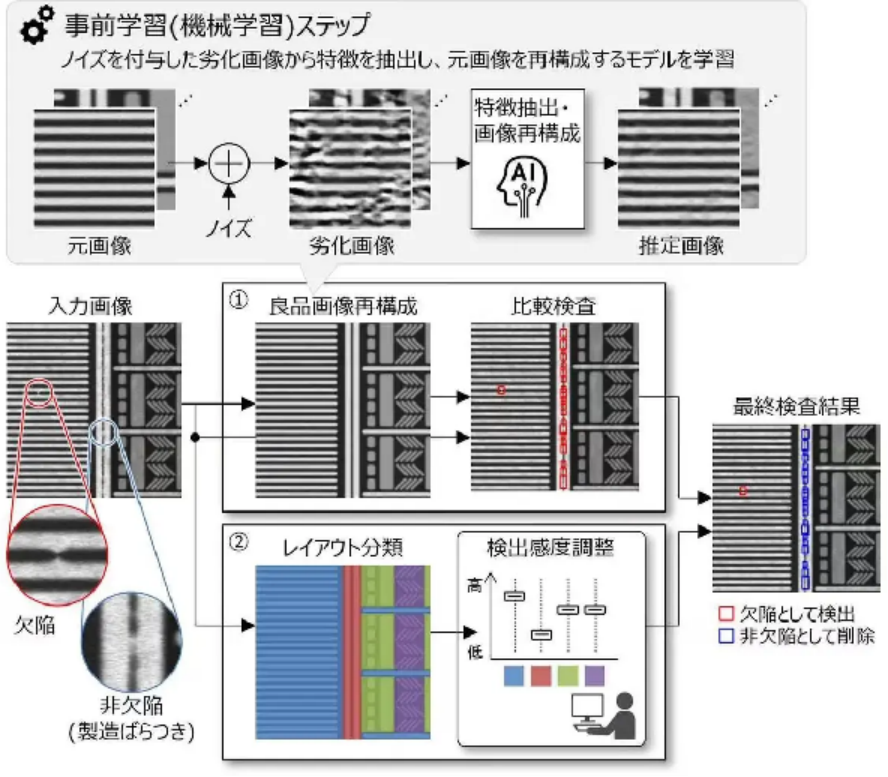
随着半导体技术的日益进步,对高性能芯片的需求愈加强烈,制造商对质量控制的要求也在不断提升。尤其是制程微缩带来的挑战,使得微缺陷的检测变得尤为关键。日立此次推出的技术恰恰在这种背景下应运而生,解决了微缺陷检测的难题。
该技术的核心在于机器学习的应用,具体包括图像重建对比和过度检测抑制两大部分。首先,通过生成大量含噪点的“人造”缺陷图像,系统可以学习并提取微缺陷的特征。在实际应用中,系统会对扫描电镜照片进行无缺陷版本的重建,进而进行对比,从中准确识别出缺陷。
此外,随着半导体制程微缩的推进,电路与缺陷的差异逐渐模糊,过度检测问题也日益严重。日立的技术通过对电路布局进行分类,并根据特定特征调节灵敏度,有效减少了90%的过度检测,提升了检测精度。

