
TEL在其年度报告上将极紫外光刻的湿法路线与干法路线进行了对比。TEL首先比较了两种路线所需要的环节,湿法MOR工艺仅需要经过涂胶-曝光-显影,而干法工艺路线涉及了六个环节。

同时,TEL还对比了湿法工艺与干法工艺的成本与碳排放,总体来看,湿法工艺路线比干法路线划算不止一点半点。当然,TEL的这种叙述,也可能来源于气相沉积光刻胶的这一新思路会抛弃Track设备,这会直接影响TEL在极紫外光刻工艺路线上对涂胶显影设备的绝对垄断地位。东京电子和光刻胶行业的老牌企业并没有袖手旁观,等着被Lam的干法路线颠覆。这就是Inpria的用武之地。他们开发了一种新型光刻胶——金属氧化物光刻胶(MOR)。2007年,Inpria出生在俄勒冈州立大学研究中心。此后,Inpria获得了三星、英特尔、应用材料、台积电、SKHynix、JSR和TOK的重大投资。MOR仍然使用与当前光刻工艺相似的步骤。它通过溶液中而旋转成晶圆片。同样的东京电子涂胶显影机可以相应的升级。这种升级不是资本密集型的,可以使用CAR或MOR光刻胶。
MOR仍然是湿式的,这意味着某些问题将继续存在,即旋涂不均匀性。光刻胶在晶圆上的潜在不均匀沉积可能导致曝光和烘烤过程步骤的问题。Lam Research的干阻胶技术的最大优点之一是使用化学气相沉积 (CVD) 工艺沉积光刻胶,这使得光刻胶的可变性和厚度得到更精细的控制。在光刻胶上获得合适的厚度是非常重要的。如果存在极薄的层,则光刻工具具有更高的性能和吞吐量,因为需要暴露的光刻胶较少。另一方面,当蚀刻(负性光刻胶)时,薄的光刻胶薄膜可能被损坏。厚的光刻胶层不仅会导致较低的吞吐量,还会导致图案坍塌,并且在显影后残留光刻胶在孔中。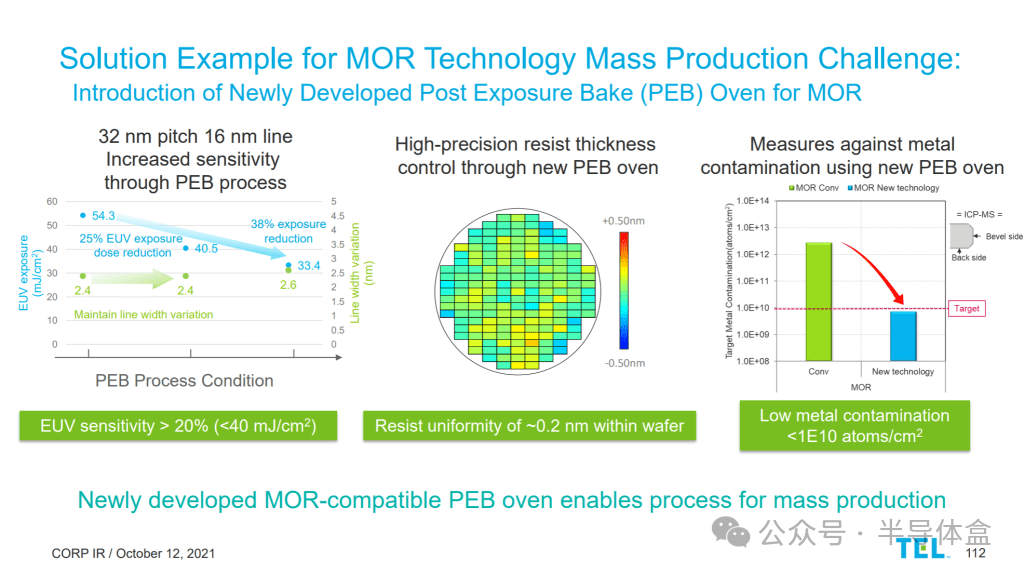
东京电子和JSR声称他们有一种新的金属氧化物抗蚀剂曝光后烘烤工艺,有助于提高光刻胶的灵敏度。这意味着晶圆厂可以大大减少EUV机器所需的剂量,从而提高吞吐量。东京电子声称减少了38%的剂量,而Lam Research声称减少了50%的抗干性。东京电子还声称,新的曝光后烘烤允许非常均匀的膜厚和低金属污染。如果这些能成功,那么这可以延长湿式光刻胶的使用寿命。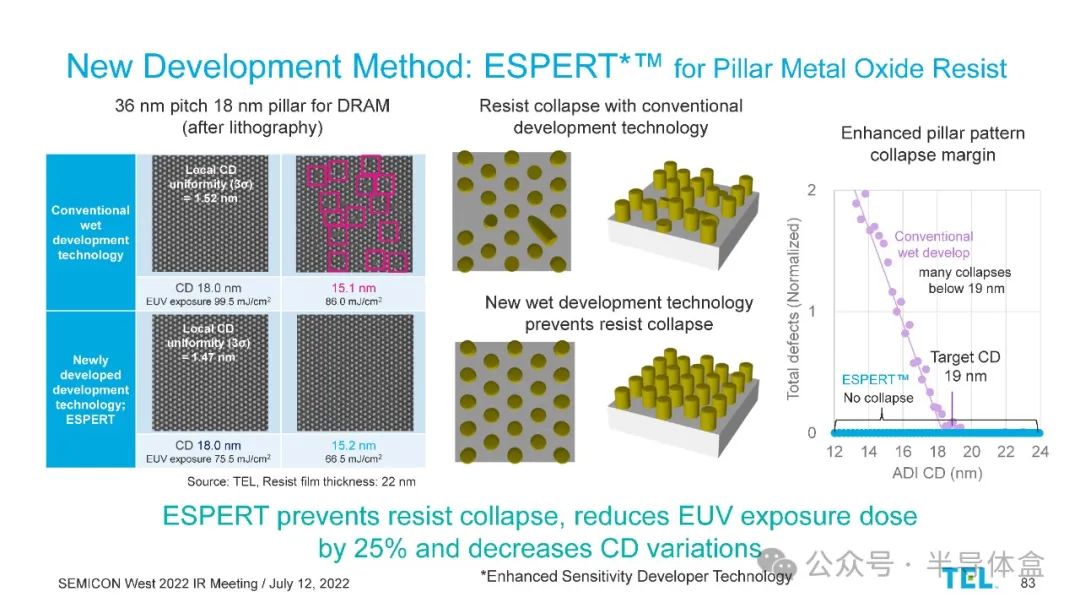
同样,东京电子和JSR也有一种名为ESPERT (*Enhanced Sensitivity Developer Technology) 的显影工艺,可以抵抗线条坍塌问题。36nm的胶柱经常坍塌,这是DRAM中电容缩放的最大挑战之一。新的显影过程也适用于较低的EUV剂量,并减少了最终图形的厚度变化问题。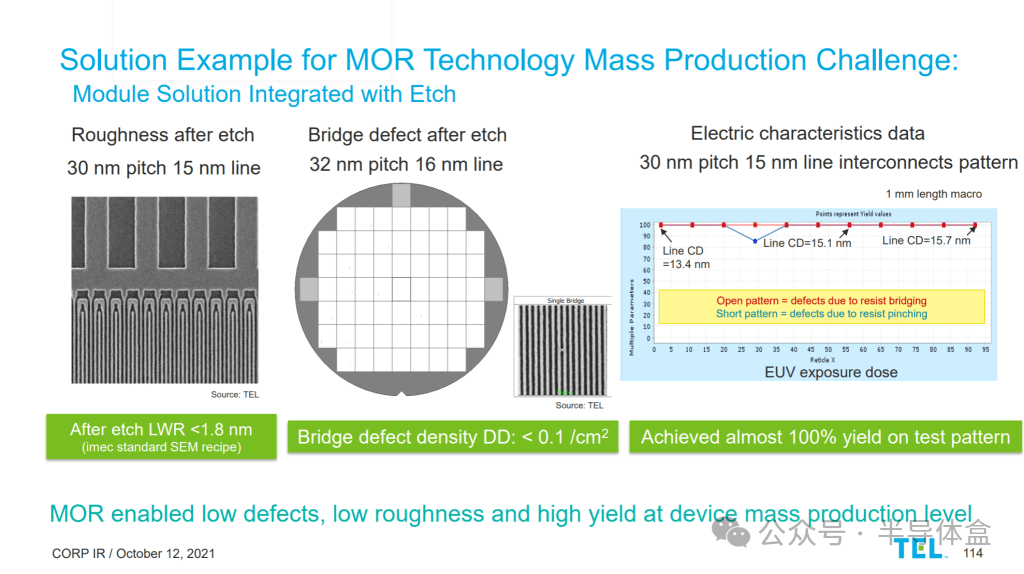
通过MOR,东京电子正在努力优化从涂胶,烘烤,显影,一直到刻蚀的整个工艺流程。他们声称已经实现了每平方厘米0.1个缺陷的密度。听起来很不错,但这样的缺陷密度意味着每300mm晶圆有70.6个缺陷。光刻工艺在前沿晶圆上完成70多次,N3工艺将在每个晶圆上进行20多次EUV光刻。这些缺陷会真的叠加起来破坏良率。MOR仍有一些障碍需要克服。改编自:semianalysis
Lam Research, Tokyo Electron, JSR Battle It Out In The $5B+ EUV Photoresist, Coater, and Developer Market - CAR vs MOR vs Dry Resist
© 滤波器 微信公众号