封装已经变得更加复杂,并且是高级 SoC 芯片组整体性能的差异化因素。它可以显着影响外形尺寸,有助于使多芯片封装中的设计小型化并改善芯片-芯片 RC 延迟。
异构集成 (HI) 继续成为开发和采用先进封装技术的关键驱动力,Apple M1 Ultra 则利用了台积电的先进封装产品,并提供了对未来先进封装前景的令人信服的愿景。

图 1. Apple M1 Ultra 处理器
Apple M1 Ultra 封装通过使用硅 (Si) 桥芯片连接两个相同的处理器,将 M1 Max 片上系统 (SoC) 驱动到其逻辑目的地。在 M1 Max 处理器上观察到的高密度互连的大未使用区域支持高速和高带宽桥接。然而,台积电的集成扇出本地硅互连 (InFO-L) 技术至关重要。Si 桥将处理器连接在一起,实现了低电阻、低延迟和高带宽。Ultra 是 TechInsights 记录的第一个使用 InFO-L 技术的设备示例。
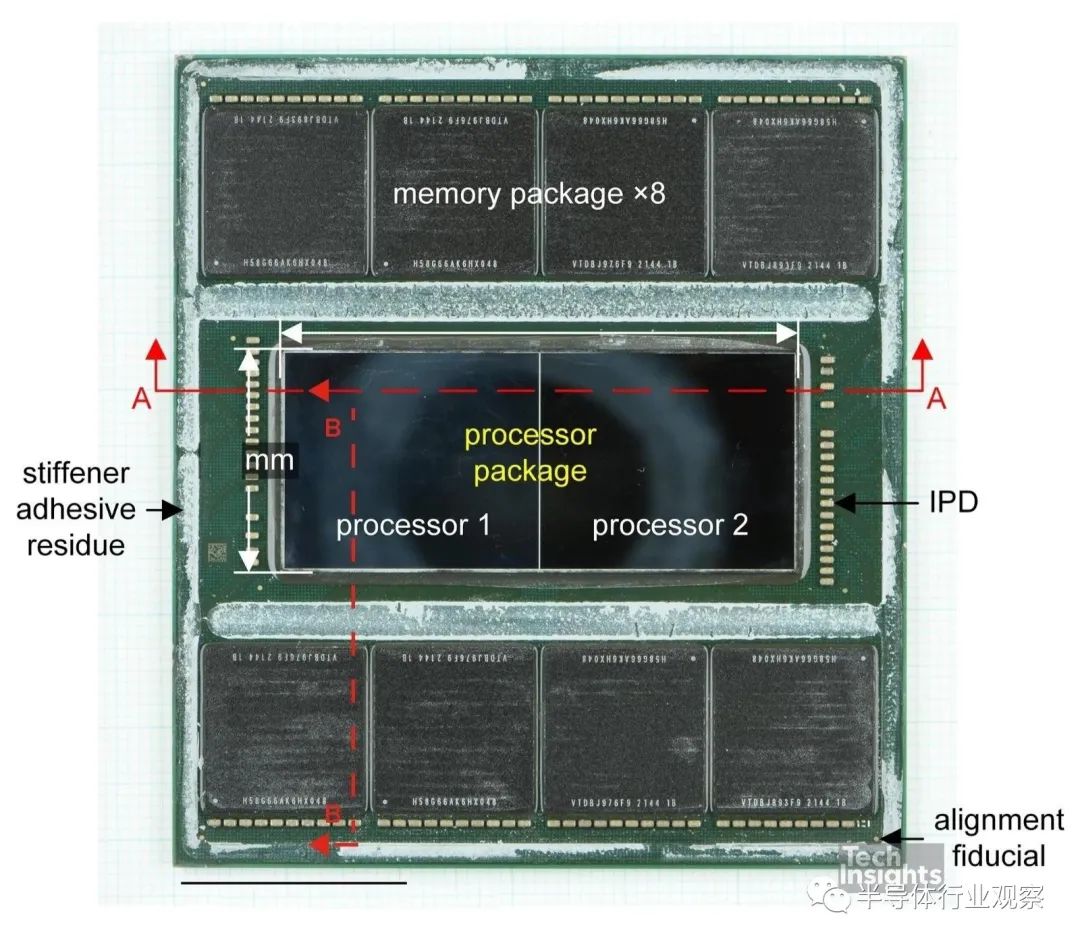
图 2. 移除散热器和加强板后的 Apple M1 Ultra 封装(俯视图)
单个 M1 Max 处理器是一个大于 400 mm 2的大芯片,但很大一部分专用于连接到 Si 桥所需的高密度互连焊盘。Apple 为其生产的每个 M1 Max 支付该面积和成本罚款,即使是那些最终没有采用 Ultra 封装的芯片也是如此。这些额外成本直接来自采用本地硅互连封装策略,那么有什么好处驱使苹果做出这种权衡呢?

图 3. Apple M1 Ultra 封装(剖视图)
生产几乎是 M1 Max 两倍大的die的实用性和成本无疑是其中之一。建立在先进的台积电 5 纳米节点上并朝着最大光罩极限迈进,这个假设的处理器也可以预期比 M1 Max 遭受更高的比例良率损失。这种观点使得拆分芯片并创建像 M1 Max 处理器这样的产品很有吸引力。
除了实用性之外,从单个 SoC 制造两个独立产品(Max 和 Ultra)的决定还带来了许多其他设计和运营优势。单个零件编号将简化供应链并减少整个生产周期的开销。
设计像 M1 Ultra 这样的产品会出现一个问题,而在芯片级别没有解决方案。相反,需要一个包装解决方案,这正是苹果所采取的路线。该解决方案具有成本和收益,所有制造商在部署类似封装技术时都必须考虑这一点。


